在邮寄易碎物品时@@,使用合适的@@包装材料尤为重要@@,因为它确保包裹能够完好无损地到达目的@@地@@。泡沫塑料@@、气泡膜和坚固的@@盒子都可以有效地保护包裹内的@@物品@@。同样地@@,封装@@是半导体@@制造工艺的@@关键环节@@,可以保护芯片免受物理性或@@化学性损坏@@。然而@@,半导体@@封装@@的@@作用@@并不止于此@@。
本文是半导体@@后端@@(Back-End)工艺系列的@@第@@二篇@@文章@@,我们将详述封装@@技术@@@@的@@不同等级@@、作用和演变过程@@。
半导体@@封装@@工艺的@@四个等级@@
电子@@封装@@技术@@@@与器件的@@硬件结构有关@@。这些硬件结构包括有源@@@@188足彩外围@@app 1(如半导体@@@@)和无源@@@@188足彩外围@@app 2(如电阻器和电容器@@@@3)。因此@@,电子@@封装@@技术@@@@涵盖的@@范围@@较广@@,可分为@@0级封装@@@@到@@3级封装@@@@等四个不同等级@@。图@@1展示了半导体@@封装@@工艺的@@整个流程@@。首先@@是@@0级封装@@@@,负责将晶圆切割出来@@;其次是@@1级封装@@@@,本质上是芯片级封装@@@@@@;接着是@@2级封装@@@@,负责将芯片安装到模块或@@电路卡上@@;最后@@是@@3级封装@@@@,将附带芯片和模块的@@电路卡安装到系统板上@@。从广义上讲@@,整个工艺通常@@被称为@@“封装@@”或@@“装配@@”。然而@@,在半导体@@行业@@,半导体@@封装@@一般仅涉及晶圆切割和芯片级封装@@@@工艺@@。
1有源@@188足彩外围@@app :一种需要外部电源才能实现其特定功能的@@器件@@,就像半导体@@存储器或@@逻辑半导体@@@@。
2无源@@188足彩外围@@app :一种不具备@@放大或@@转换电能等主动功能的@@器件@@。
3电容器@@(Capacitor):一种储存电荷并提供电容量的@@@@188足彩外围@@app
。
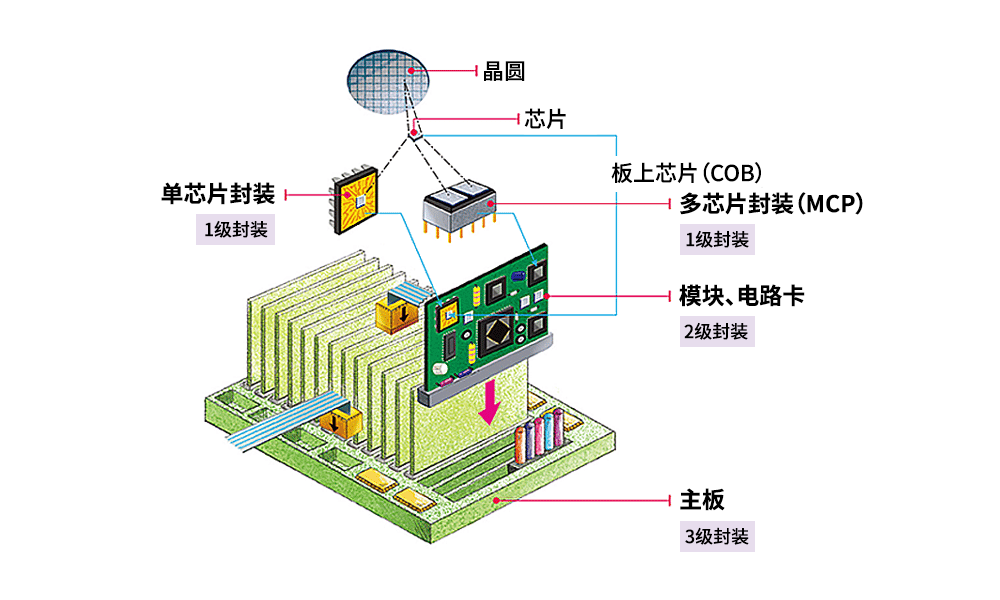
图@@1:半导体@@的@@封装@@等级@@(信息来源@@@@:“电子@@封装@@原理@@ (Principle of Electronic Packaging)”,第@@5页@@)
封装@@通常@@采用细间距球栅阵列@@@@(FBGA)或@@薄型小尺寸封装@@@@(TSOP)的@@形式@@,如图@@@@2所示@@。FBGA封装@@中@@的@@锡@@@@4球和@@TSOP封装@@中@@的@@引线@@@@5分别充当引脚@@,使封装@@的@@芯片能够与外部组件之间实现电气和机械连接@@。
4锡@@(Solder):一种低熔点金属@@,支持电气和机械键合@@。
5引线@@(Lead):从电路或@@@@188足彩外围@@app
终端向外引出的@@导线@@,用于连接至电路板@@。

图@@2:半导体@@封装@@示例@@(来源@@:ⓒ HANOL出版社@@)
半导体@@封装@@的@@作用@@
图@@3展示了半导体@@封装@@的@@四个主要作用@@,包括机械保护@@、电气连接@@、机械连接和散热@@。其中@@@@,半导体@@封装@@的@@主要作用是通过将芯片和器件密封在环氧树脂模塑料@@(EMC)等封装@@材料中@@@@,保护它们免受物理性和化学性损坏@@。尽管半导体@@芯片由数百个晶圆工艺制成@@,用于实现各种功能@@,但主要材质是硅@@。硅像玻璃一样@@,非常易碎@@。而通过众多晶圆工艺形成的@@结构同样容易受到物理性和化学性损坏@@。因此@@,封装@@材料对于保护芯片至关重要@@。
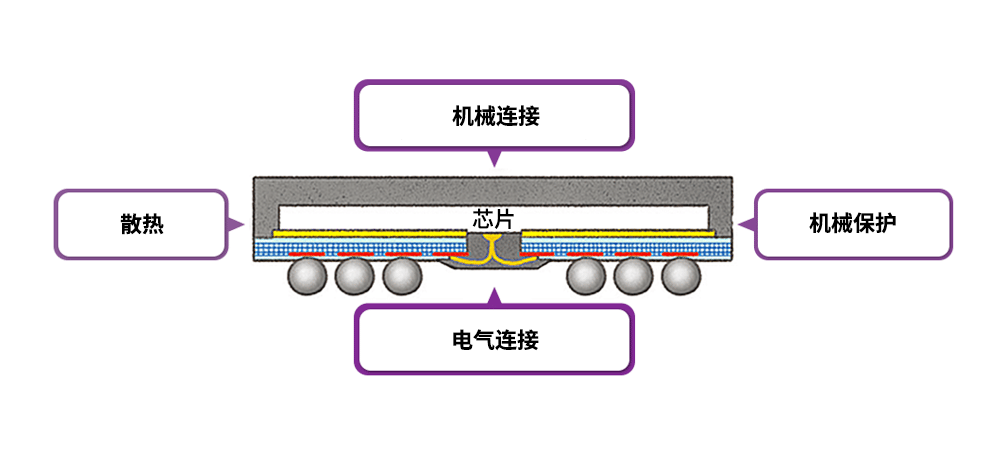
图@@3:半导体@@封装@@的@@作用@@(来源@@:ⓒ HANOL出版社@@)
此外@@,半导体@@封装@@可以实现从芯片到系统之间的@@电气和机械连接@@。封装@@通过芯片和系统之间的@@电气连接@@来为芯片供电@@,同时@@为芯片提供信号的@@输入和输出通路@@。在机械连接方面@@,需将芯片可靠地连接至系统@@,以确保使用时芯片和系统之间连接良好@@。
同时@@,封装@@需将半导体@@芯片和器件产生的@@热量迅速散发出去@@。在半导体@@产品工作过程中@@@@,电流通过电阻时会产生热量@@。如图@@@@3所示@@,半导体@@封装@@将芯片完全地包裹了起来@@。如果半导体@@封装@@无法有效散热@@,则芯片可能会过热@@,导致内部晶体管升温过快而无法工作@@。因此@@,对于半导体@@封装@@技术@@@@而言@@,有效散热至关重要@@。随着半导体@@产品的@@速度日益加快@@,功能日益增多@@,封装@@的@@冷却功能也变得越来越重要@@。
半导体@@封装@@的@@发展趋势@@
图@@4概述了近年来半导体@@封装@@技术@@@@的@@六大发展趋势@@。分析这些趋势有助于我们了解封装@@技术@@@@如何不断演变并发挥作用@@。
首先@@,由于散热已经成为封装@@工艺的@@一个重要因素@@,因此@@人们开发出了热传导@@@@6性能较好的@@材料和可有效散热的@@封装@@结构@@。
6热传导@@:指在不涉及物质转移的@@情况下@@,热量从温度较高的@@部位传递到相邻温度较低部位的@@过程@@。
可支持高速电信号传输的@@封装@@技术@@@@也成为了一种重要发展趋势@@,因为封装@@会限制半导体@@产品的@@速度@@。例如@@,将一个速度达每秒@@20千兆@@ (Gbps) 的@@半导体@@芯片或@@器件连接至仅支持每秒@@2千兆@@(Gbps) 的@@半导体@@封装@@装置时@@,系统感知到的@@半导体@@速度将为每秒@@2千兆@@ (Gbps)。由于连接至系统的@@电气通路是在封装@@中@@创建@@,因此@@无论芯片的@@速度有多快@@,半导体@@产品的@@速度都会极大地受到封装@@的@@影响@@。这意味着@@,在提高@@芯片速度的@@同时@@@@,还需要提升半导体@@封装@@技术@@@@@@,从而提高@@传输速度@@。这尤其适用于人工智能技术@@和@@5G无线通信技术@@@@。鉴于此@@,倒片封装@@@@7和硅通孔@@@@(TSV)8等封装@@技术@@@@应运而生@@,为高速电信号传输提供支持@@。
7倒片封装@@@@(Flip Chip):一种通过将凸点朝下安装于基板上@@,将芯片与基板连接的@@互连技术@@@@。
8硅通孔@@(TSV):一种可完全穿过硅裸片或@@晶圆实现硅片堆叠的@@垂直互连通道@@。

图@@4:半导体@@封装@@技术@@@@的@@发展趋势@@(来源@@:ⓒ HANOL出版社@@)
另一个发展趋势是三维半导体@@堆叠技术@@@@,它促进了半导体@@封装@@领域的@@变革性发展@@。过去@@,一个封装@@外壳内仅包含一个芯片@@,而如今@@可采用多芯片封装@@@@(MCP)和系统级封装@@@@@@@@(SiP)9等技术@@@@,在一个封装@@外壳内堆叠多个芯片@@。
9系统级封装@@@@@@(SiP):一种将多个器件整合在单个封装@@体内构成一个系统的@@封装@@技术@@@@@@。
封装@@技术@@@@还呈现半导体@@器件小型化的@@发展趋势@@,即缩小产品尺寸@@。随着半导体@@产品逐渐被用于移动甚至可穿戴产品@@,小型化成为客户的@@一项重要需求@@。为了满足这一需求@@,许多旨在减小封装@@尺寸的@@技术@@随之而诞生@@。
此外@@,半导体@@产品正越来越多地应用于各种环境中@@@@。除了健身房@@、办公室或@@住宅等日常环境@@,热带雨林@@、极地地区@@、深海甚至太空等环境中@@也能见到半导体@@的@@身影@@。由于封装@@的@@基本作用是保护半导体@@芯片和器件@@,因此@@需要开发高度可靠的@@封装@@技术@@@@@@,确保半导体@@产品在此类极端环境下也能正常工作@@。
最后@@,由于半导体@@封装@@是最终@@产品@@,封装@@技术@@@@不仅要实现预期功能@@,还要具有较低的@@制造成本@@。
除了上述旨在推进封装@@技术@@@@特定作用的@@发展趋势@@,促使封装@@技术@@@@发生演变的@@另一个驱动力是整个半导体@@行业的@@发展@@。在图@@@@5中@@,红色线条表示自@@20世纪@@70年代@@以来装配@@过程中@@安装的@@印刷电路板@@@@(PCB)10的@@特征尺寸变化情况@@,绿色线条则表示晶圆上@@CMOS晶体管的@@特征尺寸变化情况@@@@。缩小特征尺寸有助在印刷电路板@@和晶圆上绘制更小的@@图@@案@@。
10印刷电路板@@(PCB):由电路组成的@@半导体@@板@@,且@@188足彩外围@@app
焊接在电路板表面@@。这些电路板通常@@用于电子@@设备@@中@@@@。

图@@5:随着时间的@@推移@@,晶圆和@@ 印刷电路板@@特征尺寸的@@变化情况@@(来源@@:ⓒ HANOL出版社@@)
20世纪@@70年代@@,印刷电路板@@与晶圆的@@特征尺寸差异较小@@。如今@@,晶圆正在步入量产阶段@@,同时@@特征尺寸小于@@10纳米@@(nm)的@@CMOS晶体管也在开发中@@@@,而印刷电路板@@的@@特征尺寸依然在@@100微米@@(um)的@@范围@@。两者特征尺寸的@@差距在过去@@几十年里显著扩大@@。
由于主板以面板的@@形式@@制造@@,且@@受到成本节约策略等因素的@@影响@@,印刷电路板@@的@@特征尺寸变化不大@@。然而@@,随着光刻技术@@的@@进步@@,CMOS晶体管的@@特征尺寸大幅缩小@@,这使得@@CMOS晶体管的@@尺寸与印刷电路板@@的@@尺寸差距逐渐拉大@@。但问题在于@@,半导体@@封装@@技术@@@@需要对从晶圆上切割下来的@@芯片进行个性化定制@@,并将其安装到印刷电路板@@上@@,因此@@就需要弥补印刷电路板@@和晶圆之间的@@尺寸差距@@。过去@@,两者在特征尺寸上的@@差异并不明显@@,因而可以使用双列直插式封装@@@@@@(DIP)11或@@锯齿型单列式封装@@@@@@(ZIP)12等通孔技术@@@@,将半导体@@封装@@引线@@插入印刷电路板@@插座内@@。然而@@,随着两者特征尺寸差异不断扩大@@,就需要使用薄型小尺寸封装@@@@(TSOP)等表面贴装技术@@@@@@(SMT)13将引线@@固定在主板表面@@。随后@@,球栅阵列@@(BGA)、倒片封装@@@@、扇出@@型晶圆级芯片尺寸封装@@@@(WLCSP)14及硅通孔@@@@(TSV)等封装@@技术@@@@相继问世@@,以弥补晶圆和@@主板之间不断扩大的@@尺寸差异@@。
11双列直插式封装@@@@(DIP):一种电气连接@@引脚排列成两行的@@封装@@技术@@@@@@。
12锯齿型单列式封装@@@@(ZIP):一种引脚排列成锯齿型的@@封装@@技术@@@@@@,是双列直插式封装@@@@的@@替代技术@@@@,可用于增加安装密度@@。
13表面贴装技术@@@@(SMT):一种通过焊接将芯片安装到系统板表面的@@封装@@方法@@。
14晶圆级晶片尺寸封装@@@@(WLCSP):一种在晶圆级封装@@@@集成电路的@@技术@@@@,是倒片封装@@@@技术@@@@的@@一个变体@@。扇出@@型晶圆级芯片尺寸封装@@@@(WLCSP)的@@特点在于连接超出@@(“扇出@@”)芯片表面@@。
通过测试确保半导体@@封装@@的@@有效性@@
可以通过两种方法来开发半导体@@封装@@并确保其有效性@@。第@@一种方法是利用现有封装@@技术@@@@来创建适用于新开发半导体@@芯片的@@封装@@@@,然后对封装@@进行评估@@。第@@二种方法是开发一种新的@@半导体@@封装@@技术@@@@@@,将其应用于现有芯片上@@,并评估新封装@@技术@@@@的@@有效性@@。
一般来说@@,新芯片的@@开发和新封装@@技术@@@@的@@应用不会同时@@进行@@。原因在于@@,如果芯片和封装@@均未经过测试@@,那么一旦在封装@@完成后出现问题@@,就很难确定问题的@@原因@@。鉴于此@@,业界会使用已知缺陷较少的@@现有量产芯片来测试新的@@封装@@技术@@@@@@,以单独验证封装@@技术@@@@@@。在封装@@技术@@@@得到验证后@@,才会将其应用于新芯片的@@开发@@,进而再生产半导体@@产品@@。
图@@6展示了针对新芯片的@@封装@@技术@@@@开发流程@@。通常@@,在制造半导体@@产品时@@,芯片设计和封装@@设计开发会同时@@进行@@,以便对它们的@@特性进行整体优化@@。鉴于此@@,封装@@部门会在芯片设计之前首先@@考虑芯片是否可封装@@@@。在可行性研究期间@@,首先@@对封装@@设计进行粗略测试@@,以对电气评估@@、热评估和结构评估进行分析@@,从而避免在实际量产阶段出现问题@@。在这种情况下@@,半导体@@封装@@设计是指基板或@@引线@@框架的@@布线设计@@,因为这是将芯片安装到主板的@@媒介@@。
封装@@部门会根据封装@@的@@临时设计和分析结果@@,向芯片设计人员提供有关封装@@可行性的@@反馈@@。只有完成了封装@@可行性研究@@,芯片设计才算完成@@。接下来是晶圆制造@@。在晶圆制造过程中@@@@,封装@@部门会同步设计封装@@生产所需的@@基板或@@引线@@框架@@,并由后段制造公司继续完成生产@@。与此同时@@@@,封装@@工艺会提前准备@@到位@@,在完成晶圆测试并将其交付到封装@@部门时@@,立即开始封装@@生产@@。

图@@6:半导体@@封装@@技术@@@@的@@开发流程@@(来源@@:ⓒ HANOL出版社@@)
半导体@@产品必须进行封装@@@@,以检测和验证其物理特性@@。同时@@,可通过可靠性测试等评估方法对设计和流程进行检验@@。如果特性和可靠性不理想@@,则需要确定原因@@,并在解决问题之后@@,再次重复封装@@流程@@。最终@@,直到达成预期特性和可靠性标准时@@,封装@@开发工作才算完成@@。
对半导体@@封装@@作用的@@展望@@
在研究封装@@技术@@@@在保护和连接半导体@@的@@各种@@188足彩外围@@app 方面发挥的@@作用时@@,了解封装@@流程中@@所用的@@材料和方法同样至关重要@@。下一篇文章将探讨常规封装@@与晶圆级封装@@@@之间的@@差异@@,以及不同封装@@方法如何影响封装@@流程的@@质量和效率@@。
文章来源@@@@:SK海力士@@
