绘制@@精细电路的@@第一步@@
金属@@-氧化物半导体@@场效应晶体管@@(MOSFET)的@@革命@@,让我们可以@@在@@相同面积的@@晶圆上@@同时制造出更多晶体管@@。MOSFET体积越小@@@@,单个@@ MOSFET的@@耗电量就越少@@,还可以@@制造出更多的@@晶体管@@,让其发挥作用@@,可谓是一举多得@@。可见@@,制造更小的@@@@MOSFET成了关键因素@@,并且想制成微细的@@电路@@,第一步就是@@“绘制@@”。
我们以@@饼干烘培做比喻来说明一下@@。假设想在@@面饼上压出数百个@@“幸福之翼@@”形状的@@饼干@@,一个一个做显然是很费力的@@@@,那要采用什么样的@@方法呢@@?

图@@1:在@@面饼上快速压出相同造型饼干的@@方法@@
最好的@@办法就是利用模具@@@@,先把面饼擀平擀宽烘培后@@@@,用饼干模具@@@@@@(印章@@)压出想要的@@形状来@@。这样一来@@,一次压出@@100个饼干也不会太吃力@@。
再想一想@@,如果想把做好的@@饼干卖给@@孩子们@@,就得把饼干做得更小@@,那要怎么办@@@@?当然@@,饼干模具@@@@就要变得更小@@。本篇文章的@@主角就是相当于@@“饼干模具@@@@”的@@“光刻@@机@@”。半导体@@制造与饼干烘培的@@最大区别在@@于@@,MOSFET越小@@,在@@相同面积的@@晶圆上@@,就可以@@制造出越多的@@@@MOSFET,这也就越受客户的@@青睐@@。两个小的@@@@MOSFET远比一个大的@@@@MOSFET更实用@@。
半导体@@的@@@@制造其实就是不断重复上述工艺@@。继续以@@做饼干为例@@@@,如果糕点师想给@@@@“幸福之翼@@”饼干上色@@,要怎么办@@?

图@@2:给@@“幸福之翼@@”饼干上色@@的@@顺序@@

图@@3:如果能成批向数十个饼干喷涂色素@@,速度就会更快@@。
图@@2和@@3揭示了快速做出更多饼干的@@方法@@:先在@@面饼上压出许多造型相同的@@饼干@@,然后@@遮盖不想上色的@@部位@@,再向整个面饼喷涂色素@@。这样就可以@@轻松快速地做出特定造型和@@颜色的@@饼干了@@。说到这里@@,也许善于思考的@@读者就要发问@@:这么多的@@双翼内侧黑色遮盖物@@@@(见图@@@@3),要怎么制作@@?下面我们会说到这一点@@,这其实就是光刻@@工艺@@的@@核心@@。
饼干只有面饼和@@色素@@(红色@@、橘黄色@@)两层@@,但半导体@@结构却复杂得多@@,由数十层堆叠组成@@:包括电子@@@@188足彩外围@@app 层还有层层堆叠的@@金属@@布线层等@@。这也是我们说光刻@@是半导体@@制程关键工艺的@@原因@@。
模具@@的@@制作过程@@:光刻@@工艺@@
半导体@@制造商把上面我们所说的@@制作饼干模具@@@@@@(遮盖物@@)的@@过程叫做光刻@@工艺@@@@。光刻@@工艺@@的@@第一步就是@@涂覆光刻@@胶@@@@@@(Photoresist)。光刻@@胶@@经@@曝光@@后@@@@@@化学性质会发生变化@@。具体而言@@,就是在@@晶圆上涂覆光刻@@胶@@@@后@@@@,用光@@(激光@@)照射晶圆@@,使光刻@@胶@@的@@指定部分的@@性质发生改变@@。
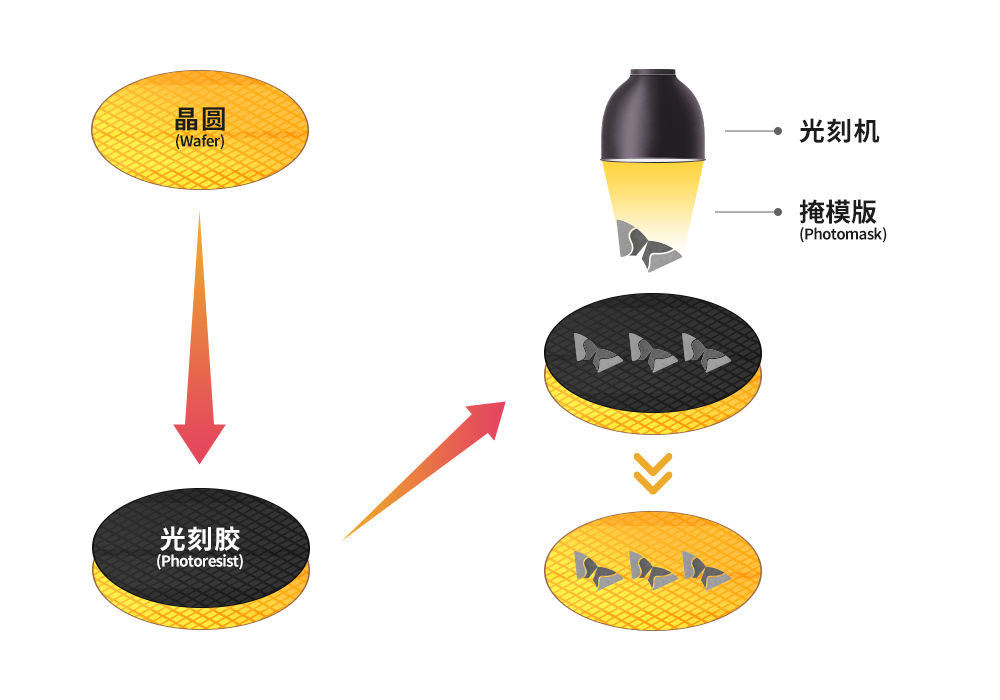
图@@4:光刻@@工艺@@基本步骤@@
如果直接用激光@@照射整个晶圆@@,那么光刻@@胶@@的@@所有部分都会发生质变@@,所以@@@@需要使光源通过特定形状的@@母版@@,再照射到晶圆上@@,这个母版就叫掩模版@@@@(Photomask)。光源通过掩模版@@照射到晶圆上@@,即可将掩模版@@的@@图@@案转印到晶圆上@@。
在@@晶圆上绘制@@图@@形后@@@@,还要经@@显影@@@@(Develop)处理@@,即在@@曝光@@后@@@@,除去曝光@@区光刻@@胶@@化学性质发生变化的@@部分@@,从而制作出所需的@@@@“饼干模具@@@@”。简言之@@,光刻@@工艺@@可以@@概括为使光源通过掩模版@@照射到涂敷光刻@@胶@@的@@晶圆表面@@,以@@将掩模版@@图@@形转印到晶圆上的@@工艺@@。
光刻@@胶@@(Photoresist)
如上所述@@,光刻@@胶@@经@@曝光@@后@@@@@@,其化学性质会发生改变@@。更准确地说@@,经@@曝光@@后@@@@,光刻@@胶@@在@@显影@@液中的@@溶解度发生了变化@@:曝光@@后@@溶解度上升的@@物质称作正性光刻@@胶@@@@@@(正胶@@),反之则为负性光刻@@胶@@@@(负胶@@)。为了更好区分@@,我们可以@@把最直观可见@@的@@物质理解为正胶@@@@。正胶@@经@@显影@@处理@@后@@@@,被曝光@@的@@区域溶于显影@@液@@,在@@后@@续的@@刻蚀@@、沉积等工艺中@@,质变的@@部分会被刻蚀去除掉@@,而没有被曝光@@部分不会受后@@续工艺的@@影响@@。
半导体@@制造商一般会根据工艺的@@目的@@选择合适的@@光刻@@胶@@@@。例如@@,负胶@@经@@曝光@@而固化的@@部分@@,在@@显影@@过程中@@,因吸收部分显影@@液而容易膨胀@@、变形@@,不适合绘制@@精细图@@形@@。因此@@,绘制@@精细图@@形通常采用正胶@@@@。但负胶@@却具有成本低以@@及在@@刻蚀@@(Etching)工艺中抗刻蚀能力更强的@@的@@优点@@。
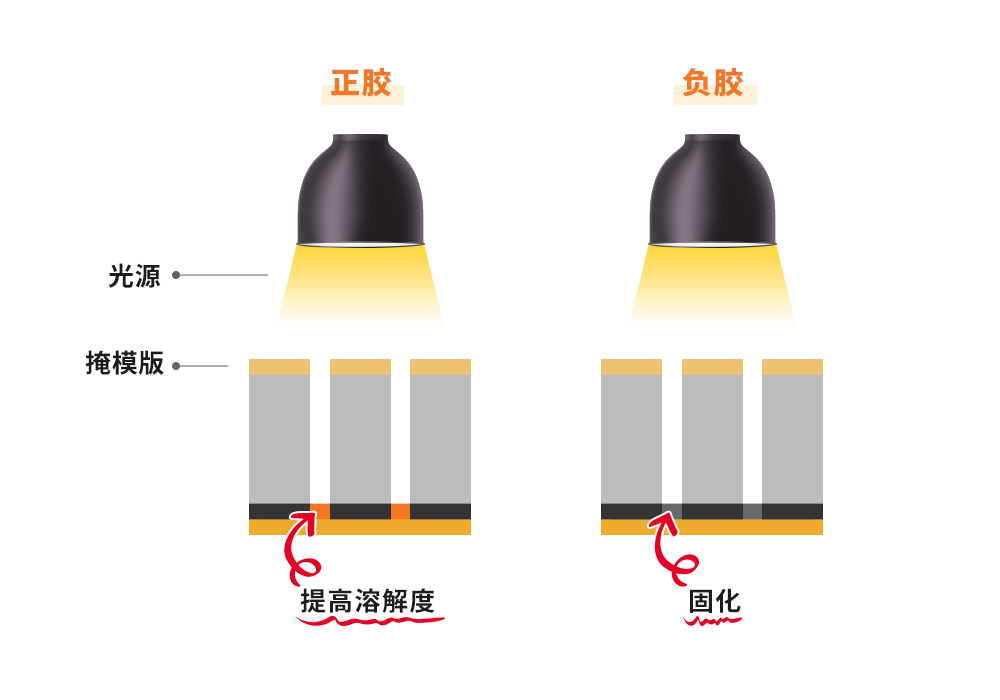
图@@5:正性光刻@@胶@@@@(正胶@@)与负性光刻@@胶@@@@(负胶@@)
选好光刻@@胶@@后@@@@,就得用涂布机@@(Coater)涂抹光刻@@胶@@@@。通过涂布机的@@高速旋转@@,滴落到晶圆的@@光刻@@胶@@可均匀伸展到整个晶圆表面@@。
光刻@@胶@@涂好后@@@@,应去除沾染在@@晶圆背面或@@边缘的@@多余胶水@@@@,再放入烘箱内加热烘烤@@,使溶剂蒸发@@,为下一道工艺做准备@@@@。
随着时代的@@发展@@,光刻@@胶@@的@@结构也变得越来越复杂@@。我们通常说@@“涂覆光刻@@胶@@@@”,但其实@@,大部分的@@光刻@@胶@@并不是一层@@,而是多层结构@@。 底部抗反射涂层@@(BARC,Bottom Anti-reflective Coatings)就是其中的@@一种@@。随着微细化技术@@的@@进一步升级@@,光刻@@机@@照射的@@光在@@晶圆表面被反射@@,进而影响到图@@形的@@绘制@@@@。为解决这一技术@@问题@@,在@@涂覆光刻@@胶@@@@前@@,可先将抗反射涂层涂覆在@@晶圆表面@@,以@@减少底部光的@@反射@@(因涂覆在@@光刻@@胶@@的@@底部@@,故称为@@Bottom)。此外@@,随着以@@水@@为介质的@@浸没式光刻@@设备@@@@ArF Immersion1问世@@,可以@@抖出水@@分并且不会损伤的@@防水@@涂层@@(顶部抗反射涂层@@,Top Anti-Reflective Coat)便应运而生@@。
在@@此我们要把重点放在@@理解如何克服引进新技术@@后@@的@@新挑战@@。以@@EUV光刻@@机@@2为例@@,高能量的@@极紫外线击中光刻@@胶@@并发生反应后@@会污染掩模版@@@@。为解决这一技术@@难题@@,一方面应深入研究光刻@@胶@@材料@@,另一方面@@要通过引进掩模版@@保护膜@@(Pellicle)解决这一问题@@。
¹ArF浸没式光刻@@机@@@@(ArF immersion) :以@@水@@取代光刻@@机@@内光的@@介质@@(空气@@),从而进一步改善性能@@
²EUV光刻@@机@@ :采用极紫外线绘制@@超精细图@@形的@@光刻@@机@@@@
掩模版@@(Photomask)

图@@6:光刻@@机@@运作图@@示@@
涂覆好光刻@@胶@@后@@@@,下一步就是在@@光刻@@胶@@上绘制@@图@@形@@。为此@@,需要一种名为掩模版@@的@@透明版@@。掩模版@@分为光可通过的@@透明区和@@遮光的@@不透明区@@。光源通过掩模版@@把图@@形投射到光刻@@胶@@上@@,从而将掩模图@@形转印到晶体上@@。设计@@掩模图@@形时会考虑光的@@干涉效果@@,因此@@,掩模版@@的@@图@@形与我们实际想绘制@@的@@图@@形会有所不同@@。
掩模版@@的@@图@@形设计@@其实就是半导体@@设计@@@@,这决定了半导体@@的@@@@用途@@。比如@@,用于@@DRAM、NAND闪存等存储器制造的@@掩模版@@@@会有很多肉眼看不到@@、非常有规律的@@重复的@@图@@形@@;而用于@@@@CPU、GPU等逻辑半导体@@@@(Logic Semiconductor)的@@掩模版@@@@,结构则相当复杂@@。
此外@@,半导体@@制造需要多个掩模版@@@@。使用掩模版@@曝光@@后@@@@,在@@随后@@的@@刻蚀@@、沉积和@@氧化工艺@@中再经@@多种处理@@@@,然后@@再重复上述过程@@@@,堆叠半导体@@的@@@@下一层@@。可见@@,所谓@@“设计@@”,其实就是为赋予芯片一定功能@@,不断制作用于@@绘制@@半导体@@各层的@@掩模版@@@@的@@过程@@。
掩模版@@是事先预备@@好的@@@@。因此@@,下一步就是找准曝光@@的@@起始位置@@,即对准@@(Alignment)。在@@之前的@@文章中我们也说过@@,在@@半导体@@制程工序中@@,光刻@@工艺@@可能需要反复数十次@@。半导体@@内细微图@@形的@@间隔仅为数十纳米@@,因此@@,误差@@一旦累积数十次@@,就很可能造成严重不良@@。因此@@,需要在@@曝光@@之前@@,寻找在@@前端工艺已形成的@@对准标志@@(Alignment Mark)。
曝光@@(Exposure)
终于到了曝光@@阶段@@,这是实际投射光源的@@阶段@@。把光@@(激光@@)投射到晶圆一个芯片@@大小的@@狭窄区域@@,待曝光@@一定时间后@@@@,光刻@@机@@将向旁边稍加移动@@,重复上述过程@@。
光刻@@机@@分辨两物点的@@能力叫做@@“物镜的@@分辨能力@@(鉴别率@@)”。物镜分辨能力的@@公式为@@d=λ/(2NA) (λ:入射光的@@波长@@,NA:表示物镜的@@数值孔径@@)。物镜的@@分辨能力@@越高@@,两物点间最小距离@@d越小@@,即两物体仿佛重合为一个物体@@,很难分辨@@。因此@@,掩模版@@绘制@@再精细的@@版图@@也无法转印到实际的@@晶圆表面上@@。
可见@@,降低分辨能力非常重要@@@@。上述公式给@@我们揭示了两种方法@@:一是通过调节入射光的@@波长@@来克服@@。增加激光@@的@@能量可缩短入射光的@@波长@@@@。我们经@@常在@@金博宝娱乐@@@@ 中听到的@@极紫外线@@(EUV,Extreme Ultraviolet Lithography)光刻@@机@@正是通过将深紫外线@@(DUV,Deep Ultraviolet Lithography)光刻@@机@@的@@波长缩短至@@1/14(=提高@@光能@@),实现精细图@@形绘制@@的@@@@;另一方面@@,还可通过提高@@物镜的@@数值孔径@@(NA)来寻找突破口@@。提高@@光源镜头数值孔径@@,或@@使用高折射率的@@介质增加物镜的@@数值孔径@@。高数值孔径极紫外线@@(High NA EUV)光刻@@机@@就是采用了提高@@光源镜头数值孔径@@的@@方法@@,而常用的@@深紫外线光刻@@机@@@@(ArF immersion)则采用了高折射率介质的@@方法@@。
物镜的@@数值孔径其实很难直观去理解@@,<图@@7>揭示了一种相对较通俗的@@理解方法@@。相信读者可以@@从中理解光源镜头变大@@,分辨率就会提高@@@@(变小@@)的@@原理@@。
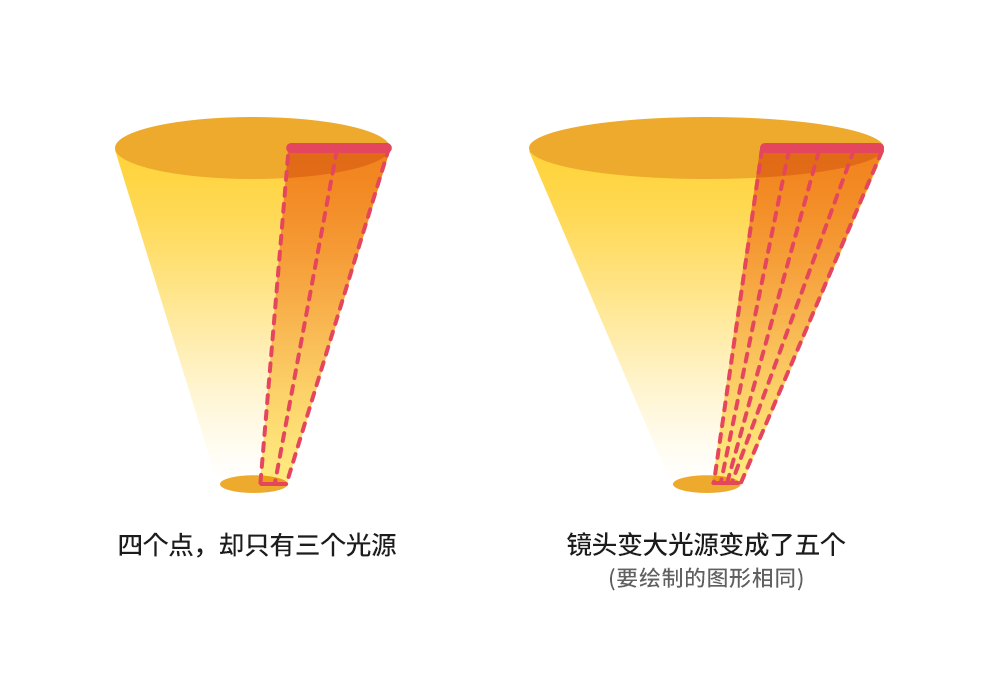
图@@7:物镜的@@数值孔径与物镜的@@分辨能力@@@@
寻找光刻@@机@@的@@光源可非同小可@@。直到@@21世纪初@@,科研人员们还在@@不断发现更好的@@光源@@。但从找到@@193nm的@@氟化氩@@(ArF)激光@@,到发现@@13.5nm的@@极紫外线作为光源@@,科学家们足足花了@@10多年的@@时间@@。这主要缘于光的@@性质@@,光的@@波长越短@@,越不容易发生折射@@,且容易被材料吸收@@。
此外@@,曝光@@对半导体@@的@@@@生产量也非常重要@@@@。从上述讲解中可以@@看出@@,曝光@@与氧化工艺@@不同@@,无法同时处理@@数十个晶圆@@,即无法打造可以@@一次处理@@直径为@@300mm的@@晶圆的@@均匀光源@@,光刻@@机@@每次只能曝光@@@@1~4个芯片@@。最新版光刻@@机@@每台约@@1000亿韩元以@@上@@,相当昂贵@@,但每小时也只能处理@@@@100张左右的@@晶圆@@。仅投入到曝光@@工艺的@@资金就是氧化工艺@@的@@@@12倍@@。对于极紫外线来说@@,与其说@@“是否能作为光源@@”重要@@,不如说@@“是否能提高@@处理@@量@@,实现商业价值@@”更加重要@@@@。为解决这一问题@@@@,不仅要从光源入手@@,还要从材料方面入手@@,寻找对少量光也能敏感反应的@@光刻@@胶@@材料@@。
曝光@@结束后@@@@,就要检测晶圆的@@套刻@@@@(Overlay)误差@@。套刻@@,是为测量光刻@@机@@的@@对准精度而在@@晶圆上做的@@小标识@@。每次曝光@@时围绕同一个中心@@,以@@不同大小的@@标记套刻@@标识@@,就可测量曝光@@的@@对准程度或@@晶圆是否有所偏离等@@。但套刻@@工艺与对准@@(Alignment)工艺不同@@,不会检测每一个晶圆的@@套刻@@精度@@。
显影@@(Develop)
光刻@@胶@@曝光@@后@@@@,曝光@@区光刻@@胶@@的@@化学性质会发生改变@@。这些变质的@@光刻@@胶@@要用显影@@液溶解后@@去除@@,这一工艺被称作显影@@@@(Develop)。
当然@@,在@@进入显影@@工艺前@@,要把晶圆放入烘箱烘烤@@,这样可以@@进一步促进曝光@@区光刻@@胶@@的@@性质变化@@,这一过程被称作曝光@@后@@烘烤@@(PEB,Post Exposure Bake)。
经@@PEB后@@,在@@晶片涂覆显影@@液@@,去除变质的@@光刻@@胶@@部分@@,必要时还可进行清洗@@(Rinse)。清洗时@@,要根据光刻@@胶@@的@@材料选择合适的@@清洗溶液@@。而清洗设备@@也是种类繁多@@,且往往要在@@处理@@速度和@@良率之间做权衡@@。
经@@上述一系列过程@@,半导体@@的@@@@“饼干模具@@@@”终于制成了@@。最后@@@@,在@@这@@“模具@@”的@@缝隙涂覆所需的@@材料@@,或@@削减不需要的@@部分等@@,经@@一番完善工作后@@在@@表面雕刻晶体管和@@金属@@布线即可@@。
光刻@@机@@的@@发展与纵向思考@@
从上述对光刻@@工艺@@的@@讲解中@@,相信读者已经@@明白以@@死记硬背的@@方式去学习一门技术@@有多么地徒劳@@。在@@193nm的@@氟化氩@@(ArF)激光@@光源遇到瓶颈时@@,科学家们还没有发现@@EUV,但微细化的@@脚步又不能停止@@。所以@@@@,研究人员们就试图@@缩短相同光源的@@波长@@,进而研发出了氟化氩浸没式光刻@@机@@@@@@,从而使半导体@@行业向@@100nm以@@下级别迈出了一步@@。当然@@,这不是仅通过光刻@@工艺@@就可以@@解决的@@@@,还需要前后@@端工艺的@@共同努力@@。
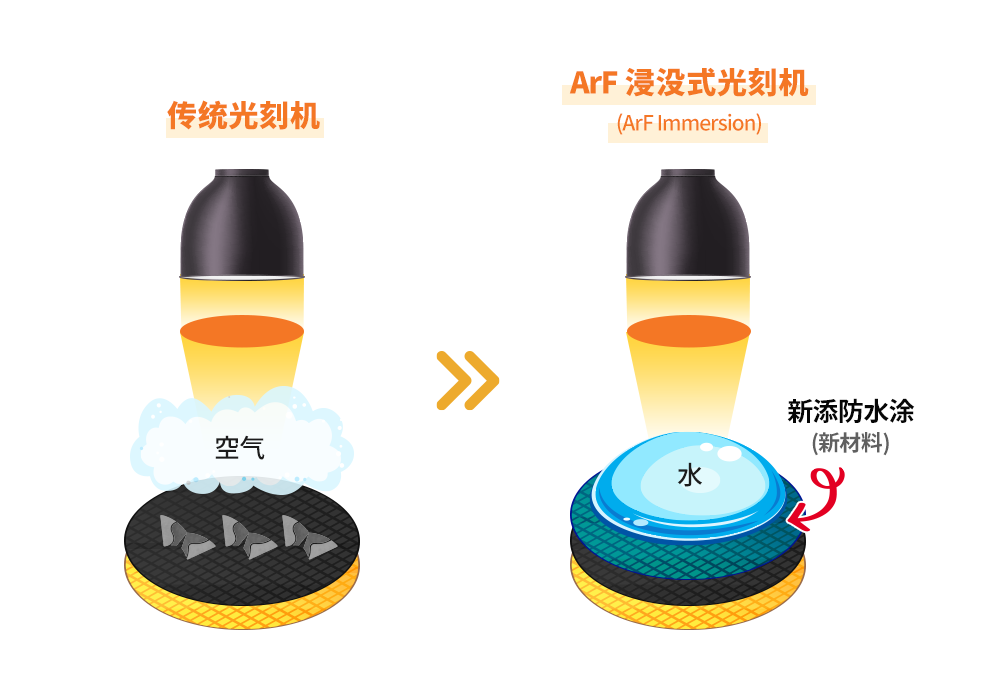
图@@8:为研发@@ArF浸没式光刻@@机@@@@所引进的@@新技术@@@@
使用浸没式光刻@@设备@@@@,就要在@@晶圆上滴落高折射率的@@液体@@(水@@)。问题是半导体@@工艺非常精细@@,小小的@@误差@@也会@@“酿成大错@@”,比如@@,液体的@@不纯物有可能导致半导体@@产品的@@瑕疵@@,或@@光刻@@胶@@被水@@溶解后@@被清洗掉等@@。为攻克这些技术@@难关@@,人们进一步研发了可以@@制成高纯度水@@的@@技术@@以@@及在@@光刻@@胶@@上形成易去除的@@防水@@涂层的@@技术@@@@。在@@光刻@@胶@@上新涂覆了一层防水@@层后@@@@,显影@@工艺当然@@也要相应做出改变@@。
这些改变@@,需要由半导体@@行业持续努力解决@@。最近@@,SK海力士@@与材料公司联手@@,共同研发了干法光刻@@工艺@@流程@@。
我们在@@前一篇@@(氧化工艺@@)中也曾说到@@,干法工艺@@,顾名思义就是没有水@@的@@介入@@。也就是说@@,这是一种与之前完全不同的@@崭新工艺技术@@@@。它像沉积工艺那样在@@光刻@@胶@@表面上形成薄膜@@,在@@显影@@过程中@@也不清洗@@。需研发这些技术@@的@@理由不胜枚举@@,但最重要@@的@@@@,就是微细化水@@平已经@@达到了极致@@,光刻@@机@@绘制@@出的@@精细图@@形@@,在@@涂覆和@@清洗光刻@@胶@@的@@过程中会被破坏@@。
结语@@ :成功绘制@@不等于结束@@
在@@本篇文章中@@,我们快速浏览了光刻@@工艺@@@@,通过该工艺@@,图@@形的@@绘制@@已经@@完成@@。下一步就需要在@@绘制@@的@@图@@形上添加点什么或@@削减不需要的@@部分@@。虽说光刻@@工艺@@很重要@@@@,但也不能忽视其他工艺@@。因为制作微细模具@@@@(光刻@@工艺@@)和@@利用这个模具@@完成所需的@@操作可是完全不同的@@问题@@。
※ 本文为外部专家对半导体@@@@/ICT的@@见解@@,并不代表@@SK海力士@@的@@立场@@。
文章来源@@:SK海力士@@
