作者@@:Coventor(泛林集团@@旗下公司@@)半导体@@工艺与整合团队成员@@Yu De Chen
原文链接@@:https://www.coventor.com/blog/how-does-line-edge-roughness-ler-affect-se...
介绍@@
由后段制程@@@@(BEOL)金属线寄生电阻电容@@(RC)造成的延迟已成为限制先进节点芯片性能的主要因素@@[1]。减小金属线间距需要更窄的线关键尺寸@@(CD)和@@线间隔@@,这会导致更高的金属线电阻和@@线间电容@@。图@@1对此进行了示意@@,模拟了不同@@后段制程@@金属的线电阻和@@线关键尺寸之间的关系@@。即使没有线边缘粗糙度@@@@(LER),该图@@也显示电阻会随着线宽缩小呈指数级增长@@[2]。为缓解此问题@@,需要在@@更小的节点上对金属线关键尺寸进行优化并选择合适的金属材料@@。
除此之外@@,线边缘粗糙度@@也是影响电子@@表@@面散射和@@金属线电阻率的重要因素@@。图@@1(b)是典逻辑@@5nm后段制程@@M2线的扫描电镜照片@@,可以看到明显的边缘粗糙度@@。最近@@,我们使用虚拟工艺建模@@,通过改变粗糙度振幅@@(RMS)、相关长度@@、所用材料和@@金属线关键尺寸@@,研究了线边缘粗糙度@@对线电阻的影响@@。

图@@1:(a) 线电阻与线关键尺寸的关系@@;(b) 5nm M2的扫描电镜俯视图@@@@(图@@片@@来源@@:TechInsights)
实验设计与执行@@
在@@晶圆厂里@@,通过改变线关键尺寸和@@金属来进行线边缘粗糙度@@变化实验很困难@@,也需要花费很多时间和@@金钱@@。由于光刻和@@刻蚀工艺的变化和@@限制@@,在@@硅晶圆上控制线边缘粗糙度@@也很困难@@。因此@@,虚拟制造也许是一个更直接和@@有效的方法@@,因为它可以@@“虚拟地@@”生成具有特定线边缘粗糙度@@的金属线结构@@,进而计算出相应显粗糙度条件下金属的电阻率@@。
图@@2(a)显示了使用虚拟半导体@@建模平台@@ (SEMulator3D®) 模拟金属线边缘粗糙度@@的版图@@设计@@@@。图@@2(b)和@@2(c)显示了最终的虚拟制造结构及其模拟线边缘粗糙度@@的俯视图@@和@@横截面图@@@@。通过设置具体的粗糙度振幅@@(RMS)和@@相关长度@@@@(噪声频率@@)值@@,可以在@@虚拟制造的光刻步骤中直接修改线边缘粗糙度@@@@。图@@2(d)显示了不同@@线边缘粗糙度@@条件的简单实验@@。图@@中不同@@@@RMS振幅和@@相关长度@@@@设置条件下@@,金属的线边缘展示出了不同@@的粗糙度@@。这些数据由@@SEMulator3D的虚拟实验仿真生成@@。为了系统地研究不同@@的关键尺寸和@@材料及线边缘粗糙度@@对金属线电阻的影响@@,使用了表@@@@1所示的实验条件进行结构建模@@,然后从相应结构中提取相应条件下的金属线电阻@@。需要说明的是@@,为了使实验更为简单@@,模拟这些结构时没有将内衬材料纳入考虑@@。
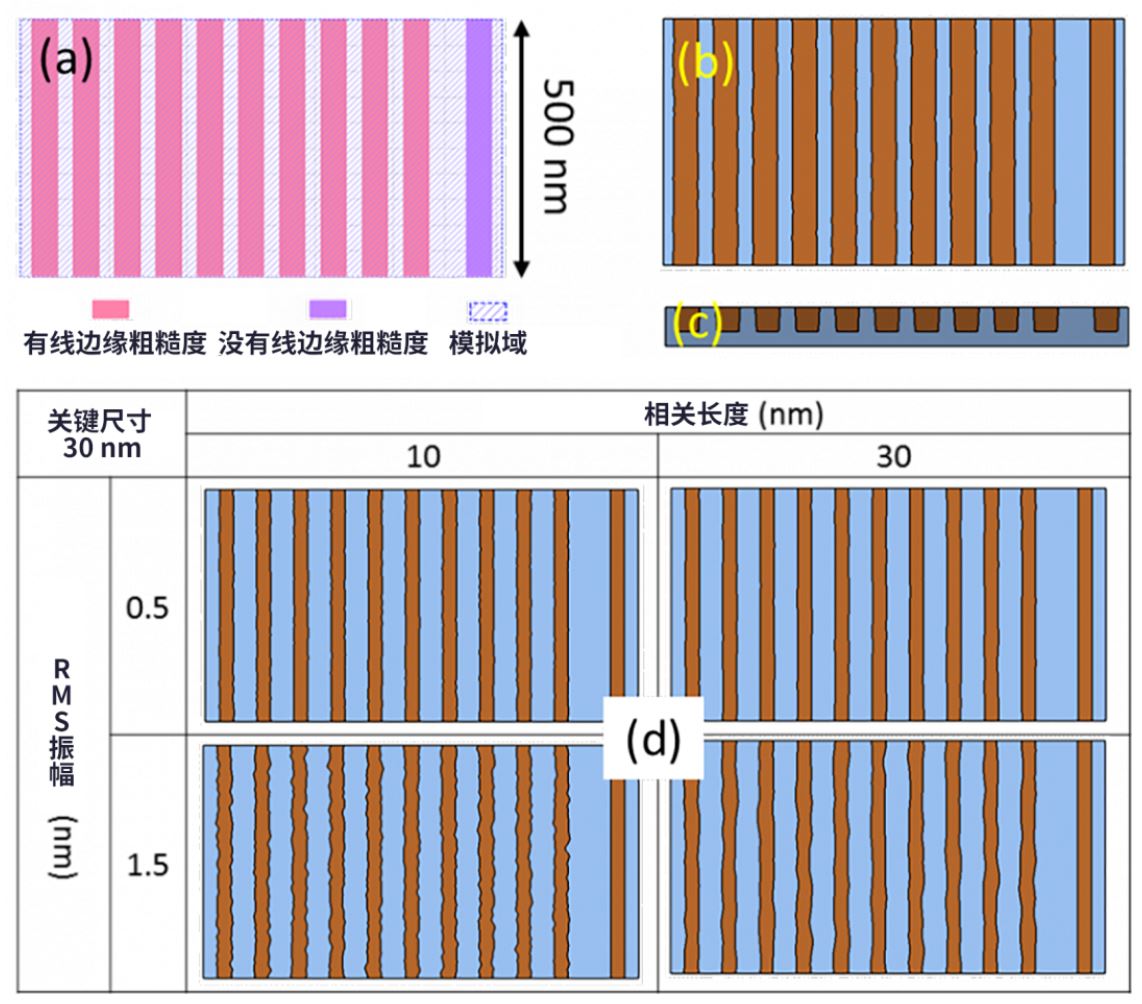
图@@2:(a) 版图@@设计@@;(b) 生成的典型金属线俯视图@@@@;(c) 金属线的横截面图@@@@;(d) 不同@@RMS和@@相关长度@@@@下的线边缘粗糙度@@状态@@

表@@1: 实验设计分割条件@@
实验设计结果与分析@@
为了探究线边缘粗糙度@@对金属线电阻的影响@@,用表@@@@1所示条件完成了约@@1000次虚拟实验设计@@。从这些实验中@@,我们了解到@@:
1. 当相关长度@@较小且存在@@高频噪声时@@,电阻受到线边缘粗糙度@@的影响较大@@。
2. 线关键尺寸较小时@@,电阻受线边缘粗糙度@@@@RMS振幅和@@相关长度@@@@的影响@@。
3. 在@@所有线关键尺寸和@@线边缘粗糙度@@条件下@@,应选择特定的金属来获得最低的绝对电阻值@@@@。
结论@@
由于线边缘粗糙度@@对较小金属线关键尺寸下的电阻有较大影响@@,线边缘粗糙度@@控制在@@先进节点将变得越来越重要@@。在@@工艺建模分割实验中@@,我们通过改变金属线关键尺寸和@@金属线材料研究了线边缘粗糙度@@对金属线电阻的影响@@。
在@@EUV(极紫外@@)光刻中@@,由于大多数@@EUV设备@@测试成本高且能量密度低@@,关键尺寸均匀性和@@线边缘粗糙度@@可能会比较麻烦@@。在@@这种情况下@@,可能需要对光刻显影进行改进@@,以尽量降低线边缘粗糙度@@@@。这些修改可以进行虚拟测试@@,以降低显影成本@@。新的@@EUV光刻胶方法@@(例如泛林集团@@的干膜光刻胶技术@@@@)也可能有助于在@@较低的@@EUV曝光量下降低线边缘粗糙度@@@@。
在@@先进节点上@@,需要合适的金属线材料选择@@、关键尺寸优化和@@光刻胶显影改进来减小线边缘粗糙度@@@@,进而减少由于电子@@表@@面散射引起的线电阻升高@@。未来的节点上可能还需要额外的线边缘粗糙度@@改进工艺@@(光刻后@@)来减少线边缘粗糙度@@引起的电阻@@。
参考资料@@:
[1] Chen, H. C., Fan, S. C., Lin, J. H., Cheng, Y. L., Jeng, S. P., & Wu, C. M. (2004). The impact of scaling on metal thickness for advanced back end of line interconnects. Thin solid films, 469, 487-490.
[2] van der Veen, M. H., Heyler, N., Pedreira, O. V., Ciofi, I., Decoster, S., Gonzalez, V. V., … & Tőkei, Z. (2018, June). Damascene benchmark of Ru, Co and Cu in scaled dimensions. In 2018 IEEE International Interconnect Technology Conference (IITC) (pp. 172-174). IEEE.
[3] Techinsights TSMC 5nm logic tear down report.
