一@@、基础知识@@
100J的@@能量@@可使@@100g水的@@温度升高约@@0.24℃。这并不是@@通过@@升高水的@@温度消耗了@@100J的@@能量@@。而@@是@@在@@水中作为热能保存了起来@@。
能量既不会凭空消失@@,也绝不会凭空产生@@。这就是@@最重要@@“能量守恒定律@@”。

℃是@@温度单位@@@@。温度是@@指像能量密度一@@样的@@物理量@@。它只不过是@@根据能量的@@多少表现出来的@@一@@种现象@@。即使能量相同@@,如果集中在@@一@@个狭窄的@@空间@@内@@,温度就会升高@@,而@@大范围分散时@@@@,温度就会降低@@。
电子@@产品接通电源后@@一@@段时@@间内@@,多半转换的@@热能会被用于提高@@装置自身的@@温度@@,而@@排出的@@能量@@仅为少数@@。之后@@@@,装置温度升高一@@定程度时@@@@,输入的@@能量@@与@@排出的@@能量@@必定一@@致@@。否则温度便会无止境上@@升@@。

热量@@的@@传递有导热@@@@,对流换热@@及辐射换热三种方式@@。在@@终端设备@@散热@@过程中@@,这三种方式都有发生@@。三种传热方式传递的@@热量@@分别由以下公式计算@@

其中@@λ、α 、ε分别为导热@@系数@@,对流换热@@系数及表面@@的@@发射率@@,A是@@
换热面积@@。
热设计@@的@@目的@@@@:
采用@@适当@@可靠的@@方法控制产品内部所有电子@@元器件的@@温度@@,使其所处的@@工作环境条件下不超过稳定运行要求的@@最高温度@@,以保证产品正常运行的@@安全性@@,长期运行的@@可靠性@@。
耗散的@@热量@@决定了温升@@@@,因此@@也决定了给定器件的@@温度@@;
热量@@以导热@@@@,对流及辐射传递出去@@,每种形式传递的@@热量@@与@@其热阻@@成反比@@;
热量@@、热阻@@和@@温度是@@设计中的@@重要参数@@。
温升@@:元器件温度与@@环境温度的@@差@@
热耗@@:元器件正常运行时@@产生的@@热量@@@@。热耗@@不等@@同于功耗@@。
热流密度@@:单位@@面积上@@的@@传热量@@@@,单位@@W/m。l热阻@@:热量@@在@@热流路径上@@遇到@@的@@阻力@@,反映介质或@@介质间的@@传热能力大小@@。
Rja,元器件的@@热源结@@构@@(junction)到@@周围冷却空气@@(ambient)的@@总热阻@@@@。
Rjc,元器件的@@热源结@@到@@封装外壳间的@@热阻@@@@@@。
Rjb,元器件的@@结@@与@@@@PCB板间的@@热阻@@@@@@。
常见的@@散热@@方式@@:
自然对流换热@@@@
通过@@自然对流的@@方式冷却@@,不必使用风扇@@,主要通过@@空气受热膨胀产生的@@浮升力使空气不断流过发热表面@@@@,实现散热@@@@。这种换热方式不需要任何辅助设备@@@@,成本低@@。
强迫对流换热@@@@-风扇冷却@@
主要有吹风与@@抽风两种方式@@
为什么要关注@@“热设计@@”?
器件极限温度承受能力是@@高压线@@,超过后@@失效率剧增@@,使用中不允许超过@@。在@@极限温度以内@@,器件失效率与@@温度仍然强相关@@,失效率随着温度升高而@@增加@@。
是@@否存在@@一@@个安全温度点@@,只要不超过这个温度点@@,失效率与@@温度就不密切@@?
理论与@@实际表明@@,多数情况下不存在@@这样的@@温度点@@。

1、热量@@传递的@@三种基本方式@@
导热@@
物体各部分之间@@不发生相对位移时@@@@,依靠分子@@、原子及自由电子@@等@@微观粒子的@@热运动而@@产生的@@热量@@称为导热@@@@。例如@@,固体@@内部的@@热量@@传递和@@不同固体@@通过@@接触面的@@热量@@传递都是@@导热@@现象@@。芯片向壳体外部传递热量@@主要就是@@通过@@导热@@@@。

导热@@过程中传递的@@热量@@按照@@Fourier导热@@定律计算@@:
傅立叶定律是@@法国著名科学家傅立叶在@@@@1822年提出的@@一@@条热力学定律@@。该定律指在@@导热@@过程中@@,单位@@时@@间内通过@@给定截面的@@导热@@量@@,正比于垂直于该截面方向上@@的@@温度变化率和@@截面面积@@,而@@热量@@传递的@@方向则与@@温度升高的@@方向相反@@。
傅立叶定律是@@热传导的@@基础@@。它并不是@@由热力学第一@@定律导出的@@数学表达式@@,而@@是@@基于实验结@@果的@@归纳总结@@@@,是@@一@@个经验公式@@。同时@@@@,傅立叶定律是@@定义材料的@@一@@个关键物性@@,热导率的@@一@@个表达式@@。
另外@@,如上@@所述@@,傅立叶定律是@@一@@个向量表达式@@。热流密度@@是@@垂直于等@@温面的@@@@,并且是@@沿着温度降低的@@方向@@。傅立叶定律适用于所有物质@@,不管它处于什么状态@@(固体@@、液体或@@者气体@@)。

一@@般说@@,固体@@的@@导热@@系数大于液体@@,液体的@@大于气体@@。例如@@:常温下纯铜的@@导热@@系数高达@@400 W/(m*℃) ,纯铝的@@导热@@系数为@@236W/(m*℃),水的@@导热@@系数为@@0.6 W/(m*℃),而@@空气仅为@@0.025W/(m*℃)左右@@。铝的@@导热@@系数高且密度低@@,所以散热@@器基本都采用@@铝合金加工@@,但在@@一@@些@@大功率芯片散热@@中@@,为了提升散热@@性能@@,常采用@@铝散热@@器嵌铜块或@@者铜散热@@器@@。
对流换热@@
对流换热@@是@@指运动着的@@流体流经温度与@@之不同的@@固体@@表面@@时@@与@@固体@@表面@@之间@@发生的@@热量@@交换过程@@,这是@@通信设备@@散热@@中中应用最广的@@一@@种换热方式@@。根据流动的@@起因不同@@,对流换热@@可以分为强制对流换热@@和@@自然对流换热@@@@两类@@。前@@者是@@由于@@泵@@、风机或@@其他外部动力源所造成的@@@@,而@@后@@者通常是@@由于@@流体自身温度场的@@不均匀性造成不均匀的@@密度场@@,由此产生的@@浮升力成为运动的@@动力@@。机柜中通常采用@@的@@风扇冷却@@散热@@就是@@最典型的@@强制对流换热@@@@。在@@终端产品中主要是@@自然对流换热@@@@@@。自然对流散热@@分为大空间@@自然对流@@(例如@@终端外壳和@@外界空气间的@@换热@@)和@@有限空间@@自然对流@@(例如@@终端内的@@单板和@@终端内的@@空气@@)。值得注意的@@是@@@@,当@@终端外壳与@@单板的@@距离小于一@@定值时@@@@,就无法形成自然对流@@,例如@@手机的@@单板与@@外壳之间@@就只是@@以空气为介质的@@热传导@@。
对流换热@@的@@热量@@按照牛顿冷却定律计算@@


热辐射@@
塑料外壳表面@@喷漆@@,PWB表面@@会涂敷绿油@@,表面@@黑度都可以达到@@@@0.8,这些都有利于辐射散热@@@@。对于金属@@外壳@@,可以进行一@@些@@表面@@处理来提高@@黑度@@,强化散热@@@@。对辐射散热@@一@@个最大错误认识是@@认为黑色可以强化热辐射@@@@,通常散热@@器表面@@黑色处理也助长了这种认识@@。实际上@@物体温度低于@@1800℃时@@,有意义的@@热辐射@@波长位于@@0.38~100μm之间@@,且大部分能量位于红外波段@@0.76~20μm范围内@@,在@@可见光波段内@@,热辐射@@能量比重并不大@@。颜色只与@@可见光吸收相关@@,与@@红外辐射无关@@,夏天人们穿浅色的@@衣服降低太阳光中的@@可见光辐射吸收@@。因此@@终端内部可以随意涂敷各种颜色的@@漆@@。
2、热阻@@的@@概念@@
对导热@@和@@对流换热@@的@@公式进行变换@@:

热量@@传递过程中@@,温度差是@@过程的@@动力@@,好象电学中的@@电压@@,换热量@@是@@被传递的@@量@@,好像电学中的@@电流@@,因而@@上@@式中的@@分母可以用电学中的@@电阻概念来理解成导热@@过程的@@阻力@@,称为热阻@@@@(thermal resistance),单位@@为@@℃/W, 其物理意义就是@@传递@@1W 的@@热量@@需要多少度温差@@。在@@热设计@@中将热阻@@标记为@@R或@@θ。δ/(λA)是@@导热@@热阻@@@@, 1/αA是@@对流换热@@热阻@@@@。器件的@@资料中一@@般都会提供器件的@@@@Rjc和@@Rja热阻@@,Rjc是@@器件的@@结@@到@@壳的@@导热@@热阻@@@@;Rja是@@器件的@@结@@到@@壳导热@@热阻@@和@@壳与@@外界环境的@@对流换热@@热阻@@之和@@@@。这些热阻@@参数@@可以根据实验测试获得@@,也可以根据详细的@@器件内部结@@构计算得到@@@@。根据这些热阻@@参数@@和@@器件的@@热耗@@@@,就可以计算得到@@器件的@@结@@温@@。

下图形象地表达了欧姆定律@@,类比欧姆定律@@,热差类比于电压@@,热阻@@类比于电阻@@,热耗@@类比于电流@@。


两个名义上@@相接触的@@固体@@表面@@@@,实际上@@接触仅发生在@@一@@些@@离散的@@面积元上@@@@,如右图所示@@,在@@未接触的@@界面之间@@的@@间隙中常充满了空气@@,热量@@将以导热@@和@@辐射的@@方式穿过该间隙层@@,与@@理想中真正完全接触相比@@,这种附加的@@热传递阻力称为接触热阻@@@@。降低接触热阻@@的@@方法主要是@@增加接触压力和@@增加界面材料@@(如硅脂@@)填充界面间的@@空气@@。在@@涉及热传导时@@@@,一@@定不能忽视接触热阻@@的@@影响@@@@,需要根据应用情况选择合适的@@导热@@界面材料@@,如导热@@脂@@、导热@@膜@@、导热@@垫等@@@@。
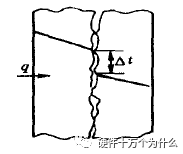
二@@、器件热特性@@
1、认识器件热阻@@@@
JEDEC芯片封装的@@热性能参数@@@@:

热阻@@参数@@
θja,结@@(即芯片@@)到@@空气环境的@@热阻@@@@@@:θja=(Tj-Ta)/P
θjc,结@@(即芯片@@)到@@封装外壳的@@热阻@@@@@@:θjc=(Tj-Tc)/P
θjb,结@@(即芯片@@)到@@PCB的@@热阻@@@@:θjb=(Tj-Tb)/P
热性能参数@@
ψjt,结@@到@@封装顶部的@@热参数@@:ψjt =(Tj-Tt)/P
ψjb,结@@到@@封装底部的@@热参数@@:ψjb =(Tj-Tb)/P
Tj——芯片结@@温@@,℃
Ta——空气环境温度@@,℃
Tb——芯片根部@@PCB表面@@温度@@,℃
Tt——芯片表面@@温度@@@@,℃
θja 热阻@@参数@@是@@封装的@@品质度量@@(Figure of Merit),并非@@Application-specific,θja的@@正确的@@应用只能是@@芯片封装的@@热性能品质参数@@(用于性能好坏等@@级的@@比较@@),不能应用于实际测试@@/分析中的@@结@@温预计分析@@。从@@90年代起@@,相对于@@θja人们更需要对实际工程师预计芯片温度有价值的@@热参数@@。适应此要求而@@出现三个新参数@@:θjb 、ψjt和@@ψjb 。
ψjb可适当@@的@@运用于热分析中的@@结@@温分析@@
ψjt可适当@@运用于实际产品热测试中的@@结@@温预计@@。
θjc是@@结@@到@@封装表面@@离结@@最近点的@@热阻@@@@值@@。
θjc测量中设法使得热流@@“全部@@”由封装外壳通过@@@@。
ψjt与@@θjc完全不同@@,并非@@是@@器件的@@热阻@@@@值@@,只是@@个数学构造物@@,只是@@结@@@@
到@@TOP的@@热特征参数@@@@,因为不是@@所有热量@@都是@@通过@@封装顶部散出的@@@@。
实际应用中@@, ψjt对于由芯片封装上@@表面@@测试温度来估计结@@温有有限的@@@@
参考价值@@。
θjb :用来比较装于板上@@表面@@安装芯片封装热性能的@@品质参数@@(Figure
of Merit),针对的@@是@@@@2s2p PCB,不适用板上@@有不均匀热流的@@芯片封装@@。
θjb与@@ψjb有本质区别@@, θjb > ψjb 。与@@ψjt同理@@, ψjb为结@@到@@@@PCB的@@
热特征参数@@。
不同封装的@@热特性@@

2、典型器件封装散热@@特性@@

普通@@SOP封装散热@@性能很差@@,影响@@SOP封装散热@@的@@因素@@分外因和@@内因@@,其中@@内因是@@影响@@@@SOP散热@@的@@关键@@。影响@@散热@@的@@外因是@@器件管脚与@@@@PWB的@@传热热阻@@和@@器件上@@表面@@与@@环境的@@对流散热@@热阻@@@@。内因源于@@SOP封装本身很高传热热阻@@@@。SOP封装散热@@主要通过@@三个途径@@:
1)die的@@热量@@通过@@@@封装材料@@(mold compound)传导到@@器件上@@表面@@然后@@对流散热@@@@,低导热@@的@@封装材料影响@@传热@@。
2)die热量@@通过@@@@pad、封装材料和@@器件底面与@@@@PWB之间@@的@@空气层后@@@@,递到@@@@PWB散热@@,低导热@@的@@封装材料和@@空气层影响@@传热@@ 。
3)die热量@@通过@@@@lead Frame传递到@@@@@@PWB,lead frame和@@die之间@@是@@极细的@@键合线@@(golden wire),因此@@die和@@leadframe之间@@存在@@很大的@@导热@@热阻@@@@,限制了管脚散热@@@@。
该封装的@@特点是@@@@die采用@@cavity up方式布置@@,pad从@@封装底部外露@@,并焊接@@
在@@PWB表面@@;或@@者在@@@@pad底部粘结@@一@@个金属@@块@@,该金属@@@@块外露于封装底部@@,并焊接@@在@@@@PWB表面@@。die的@@热量@@通过@@@@金属@@直接传递到@@@@@@@@PWB上@@,消除了原先的@@封装材料和@@空气层的@@热阻@@@@@@。

该封装相当@@与@@把底部增强散热@@型@@SOP封装倒置过来贴装到@@单板上@@@@。由于@@裸露在@@芯片上@@表面@@的@@@@pad面积很小@@,除了起到@@均匀@@die温度的@@作用外@@,实际直接散热@@的@@性能很差@@,一@@般还需要与@@散热@@器结@@合来强化散热@@@@@@。如果芯片表面@@不安装散热@@器@@,该金属@@@@pad的@@主要作用是@@把@@die传来的@@热量@@扩展开来@@,再传递给芯片内部的@@管脚@@,最后@@通过@@管脚把热量@@传递给@@PWB散热@@,金属@@pad起到@@缩短@@die和@@管脚间传热热阻@@的@@作用@@。
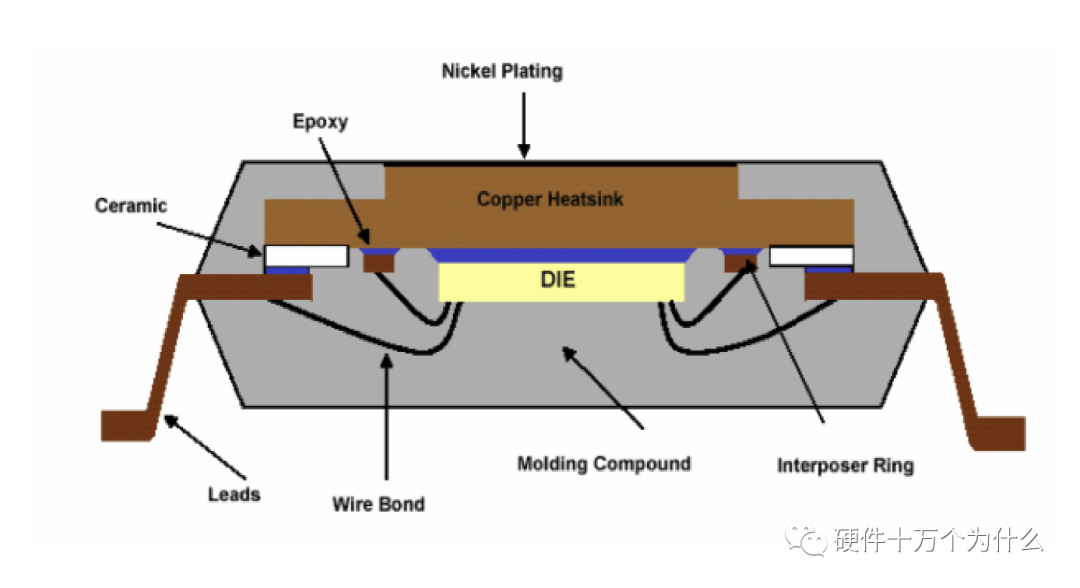
影响@@PBGA Rjc和@@Rja热阻@@的@@因素@@有很多@@,从@@重要程度看依次是@@@@:
1)thermal ball的@@个数@@
2)die的@@尺寸@@
3)substrate的@@结@@构@@,包括铜皮层数@@,铜皮厚度@@
4)die attachment 材料的@@导热@@系数@@
5)gold wire的@@直径@@
6)PWB上@@导热@@过孔@@@@的@@数量@@。
其中@@,前@@5个因素@@与@@器件本身的@@设计相关@@@@,因素@@6与@@PWB设计相关@@

一@@些@@PBGA芯片在@@表面@@贴铜块强化散热@@@@@@,由于@@mold的@@导热@@系数很低@@,该金属@@@@封装表面@@仍为辅助散热@@@@,关键散热@@路径仍在@@封装的@@底部@@。
需要了解器件内部的@@封装结@@构选择散热@@方案@@!

热量@@传递方式@@:
Die的@@热量@@传递给上@@表面@@的@@铜块@@,部分热量@@通过@@@@铜块传递到@@@@@@环境中@@;另外@@部分@@
热量@@通过@@@@铜块依次传递给芯片的@@基板@@、焊球@@、PCB后@@,通过@@PCB散热@@。

当@@FC-BGA封装热耗@@在@@@@1~6W时@@,可以采用@@直接强迫对流散热@@@@,Rja的@@范围在@@@@8~12℃/W;当@@热耗@@在@@@@4~10W时@@,需要加散热@@器强化散热@@@@@@,Rja的@@范围在@@@@5~10℃/W;当@@热耗@@为@@8~25W时@@,需要高端的@@散热@@器配合合适的@@风道来进行强化散热@@@@@@。
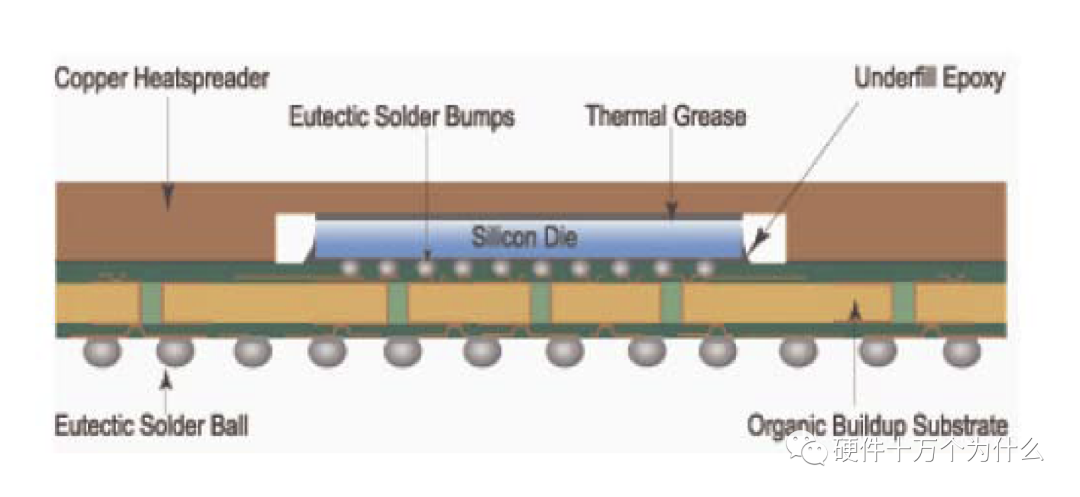
TO器件的@@散热@@往往需要较大的@@的@@铜皮@@,那么对于面积紧张的@@单板如何来实现@@?
按重要程度依次为@@:
1)过孔@@
2)单板的@@层结@@构@@(地层或@@者电源层的@@位置@@)
3)地层或@@者电源层的@@铜皮厚度@@@@
4)焊盘厚度@@


对于电子@@设备@@来说@@,工作时@@都会产生一@@定的@@热量@@@@,从@@而@@使设备@@内部温度迅速上@@升@@,如果不及时@@将该热量@@散发出去@@,设备@@就会持续的@@升温@@,器件就会因过热而@@失效@@,电子@@设备@@的@@可靠性能就会下降@@。因此@@,对电路板进行很好的@@散热@@处理是@@非常重要的@@@@。
加散热@@铜箔和@@采用@@大面积电源地铜箔@@。


根据上@@图@@可以看到@@@@:连接铜皮的@@面积越大@@,结@@温越低@@

根据上@@图@@,可以看出@@,覆铜面积越大@@,结@@温越低@@。
热过孔@@@@
热过孔@@@@能有效的@@降低器件结@@温@@,提高@@单板厚度方向温度的@@均匀性@@,为在@@@@ PCB 背面采取其他散热@@方式提供了可能@@。通过@@仿真发现@@,与@@无热过孔@@@@相比@@,在@@器件热功耗为@@ 2.5W 、间距@@ 1mm 、中心设计@@ 6x6 的@@热过孔@@@@能使结@@温降低@@ 4.8°C 左右@@,而@@ PCB 的@@顶面与@@底面的@@温差由原来的@@@@ 21°C 减低到@@@@ 5°C 。热过孔@@@@阵列改为@@ 4x4 后@@,器件的@@结@@温与@@@@ 6x6 相比升高了@@ 2.2°C ,值得关注@@。

IC背面露铜@@,减小铜皮与@@空气之间@@的@@热阻@@@@@@
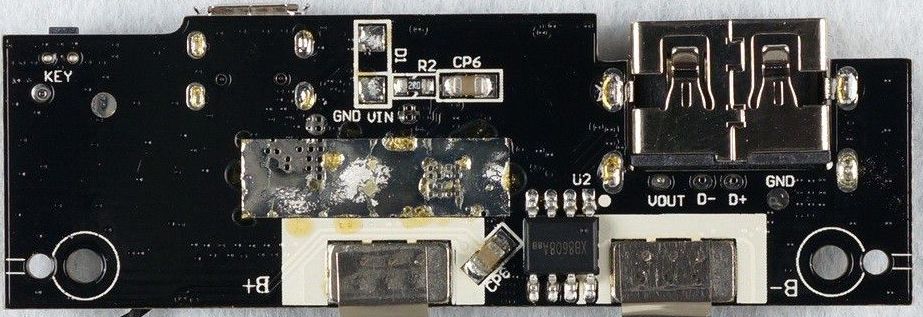
3、单板器件的@@散热@@途径@@


好的@@电路板板散热@@方案必须针对器件的@@散热@@特性进行设计@@
THD器件的@@管脚数量少@@,焊接后@@封装也不紧贴单板@@,与@@单板的@@热关联性很小@@,该类器件的@@热量@@都是@@通过@@器件表面@@散到@@环境中@@。因此@@早期的@@器件散热@@研究@@
比较注重于器件表面@@的@@空气流动@@,以期获得比较高的@@器件表面@@对流换热@@系数@@。
SMD器件集成度高@@,热耗@@也大@@,是@@散热@@关注的@@重点@@。该类器件的@@管脚@@/焊球@@数量多@@,焊接后@@封装也紧贴单板@@,与@@单板建立起紧密的@@换热联系@@,散热@@方案必须从@@单板整体散热@@的@@角度进行分析@@。SMD器件针对散热@@需求也出现了多种强化散热@@@@的@@封装@@,这些封装的@@种类繁多@@,但从@@散热@@角度进行归纳分类@@,以引脚封装和@@焊球@@封装最为典型@@,其它封装的@@散热@@特性可以参考这两种类推@@。
PGA类的@@针状管脚器件基本忽略单板散热@@@@,以表面@@散热@@为主@@,例如@@CPU等@@。