在本系列第三篇文章中@@,我们了解到半导体@@封装@@方法主要分为两种@@:传统封装@@和晶圆@@级封装@@@@@@。接下来@@,本文将重点介绍这两种封装@@方法@@,以及两者在组装方法和功能方面的差异@@。在本篇文章中@@,将着重介绍传统封装@@方法@@。
传统封装@@组装方法概述@@
图@@1显示了塑料封装@@的组装工艺@@@@,塑料封装@@是一种传统封装@@方法@@,分为引线框架封装@@@@(Leadframe Package)和基板封装@@@@(Substrate Package)。这两种封装@@工艺@@的前半部分流程相同@@,而@@后半部分流程则在引脚连接方式上存在差异@@。
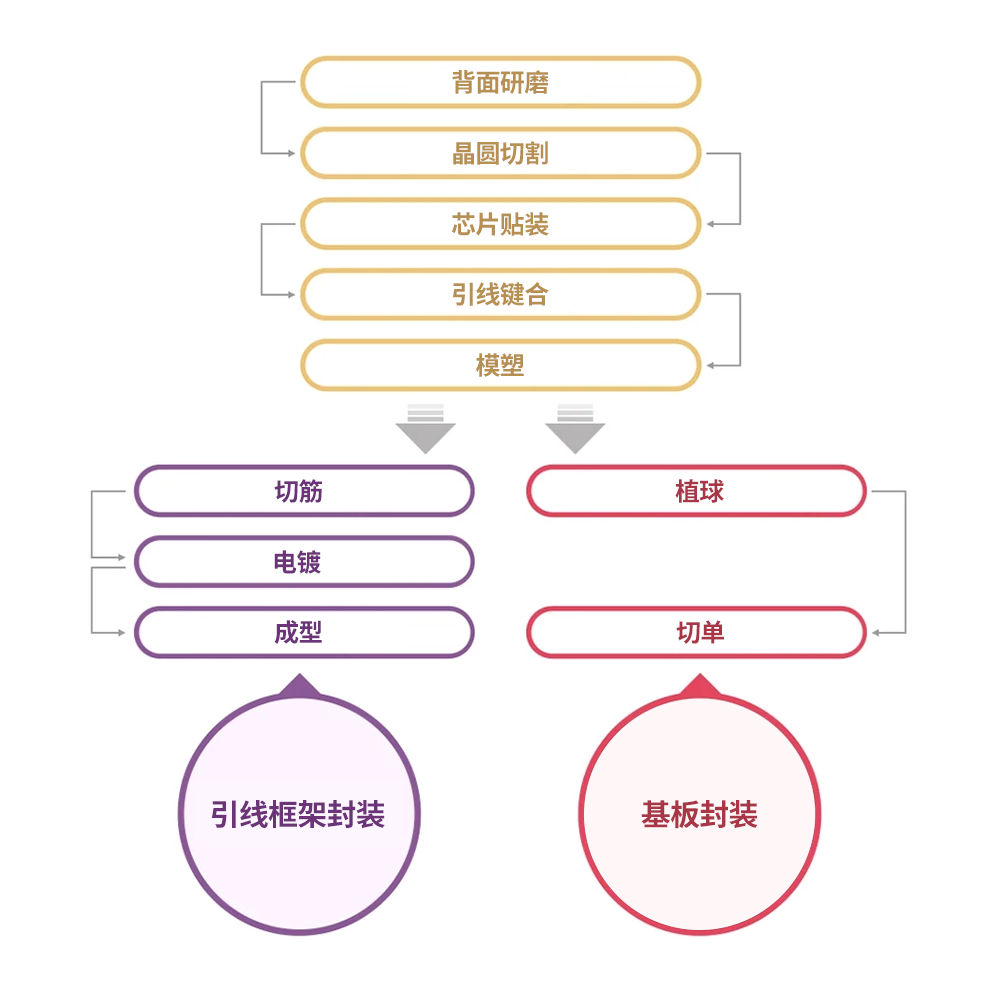
图@@1:引线框架封装@@和基板封装@@@@的组装步骤@@(ⓒ HANOL出版社@@)
晶圆@@经过测试后@@,首先要经过背面研磨@@@@(Backgrinding),以达到所需厚度@@;然后@@进行晶圆@@切割@@@@(Wafer Sawing),将晶圆@@切割@@成芯片@@;选择质量良好的芯片@@,通过芯片贴装@@@@(Die Attach)工艺@@将芯片连接到引线框架或@@基板上@@;之后通过引线键合@@@@(Wire Bonding)的方式实现芯片与基板之间@@的电气连接@@;最后@@使用环氧树脂模塑@@料@@(EMC)进行密封保护@@。引线框架封装@@和基板封装@@@@在前半部分流程中均采用上述步骤@@。
在后半部分流程中@@,引线框架封装@@采用如下步骤@@:通过切筋@@@@(Trimming)1的方式将引线分离@@;通过电镀@@(Solder Plating)将锡球置放至引线末端@@;最后@@是成型@@(Forming)工艺@@,成型工艺@@将封装@@分离为独立单元@@,并弯曲引线@@,以便将它们连接到系统板上@@。而@@对于基板封装@@@@,则是在进行植球@@@@(Solder Ball Mounting),即锡球被焊接在基板焊盘上之前@@,先完成模塑@@@@;之后进行切割@@@@,成为独立封装@@@@,也可称之为切单@@@@(Singulation)。接下来@@的内容中@@,将阐述传统封装@@方法的组装工艺@@@@,并重点介绍基板封装@@的八个步骤@@。
1 切筋@@(Trimming):一种应用于引线框架封装@@的工艺@@@@@@,使用剪切冲床去除引线之间的阻尼条@@。
第一步@@:背面研磨@@
背面研磨@@工艺@@可确保将晶圆@@加工成适合其封装@@特性的最佳厚度@@。该工艺@@包括对晶圆@@背面进行研磨@@处理并将其安装在环形框架内@@,如图@@@@2所示@@。

图@@2:晶圆@@背面研磨@@工艺@@的四个步骤@@(ⓒ HANOL出版社@@)
在对晶圆@@背面进行研磨@@之前@@,首先需要在晶圆@@正面覆盖一层保护胶带@@,称之为背面研磨@@保护胶带@@。这是为了防止用于绘制电路的晶圆@@正面遭受物理性损害@@。之后使用研磨轮@@(Grinding Wheel)对晶圆@@背面进行研磨@@,使其变得更薄@@。在这个过程中@@,需要先用高速旋转的粗磨轮去除大部分多余材料@@;再用细磨轮对表面进行精磨@@,以达到理想厚度@@;最后@@使用精拋光垫@@(Fine Pad)对晶圆@@进行抛光@@,使其表面变得光滑@@。如果晶圆@@表面粗糙@@,那么在后续工艺@@中施加应力@@(Stress)时@@,会使其更易产生裂痕@@,导致芯片断裂@@。因此@@,通过抛光来防止裂痕形成@@,对于减少芯片破损具有重要意义@@。
对于单芯片封装@@而@@言@@,通常需要将晶圆@@研磨到约@@200-250微米@@(μm)的厚度@@。而@@对于堆叠封装@@而@@言@@,因将多个芯片堆叠在同一封装@@体中@@,所以芯片@@(晶圆@@)需要研磨至更薄@@。然而@@@@,研磨晶圆@@背面所产生的残余应力会导致晶圆@@正面收缩@@,这样可能会引发晶圆@@弯曲成弧形@@;此外@@随着晶圆@@变薄@@,其弯曲度也会增加@@。因此@@为了保持晶圆@@平整@@,首先需要在晶圆@@背面贴上承载薄膜@@(Mounting Tape),然后@@将其固定在环形框架内@@。最后@@,去除用于保护晶圆@@正面器件的背面研磨@@保护胶带@@,露出半导体@@器件@@,背面研磨@@工艺@@即视为完成@@。
第二步@@:晶圆@@切割@@/分割@@
晶圆@@切割@@是指沿着晶圆@@上的划片槽@@@@(Scribe Lane)2进行切割@@,直到分离出芯片的工艺@@@@@@,也被称为划片工艺@@@@。晶圆@@切割@@是芯片封装@@工艺@@的必要工序@@。
图@@3给出了使用刀片切割法将晶圆@@分割@@为芯片的示例@@。在这种晶圆@@切割@@方法中@@,使用轮状锯片来切割和分离晶圆@@@@。这种锯片采用高硬度的金刚石刀头沿着晶圆@@划片线切割@@,晶圆@@格状划片线如图@@@@左侧所示@@@@。由于锯片旋转时@@会产生容差@@@@3,因此@@划片线宽度必须超过砂轮厚度@@。
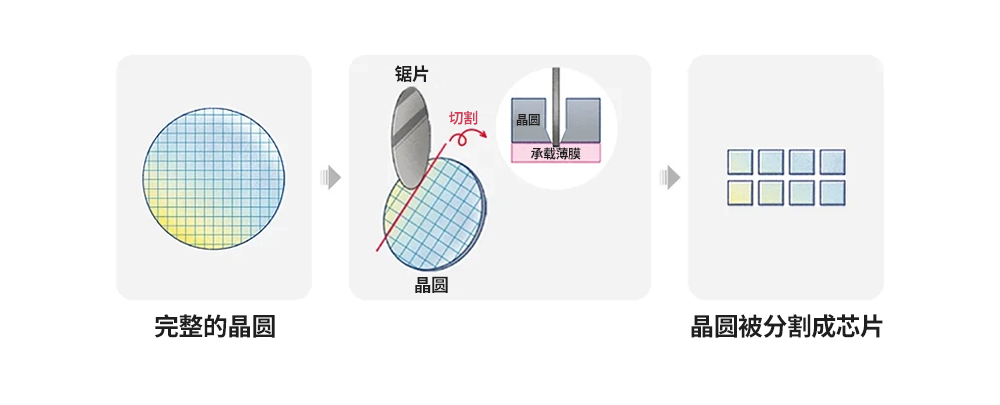
图@@3:通过刀片切割工艺@@将晶圆@@切割@@成芯片@@@@(ⓒ HANOL出版社@@)
刀片切割存在一个问题@@:由于切割过程中刀片直接接触晶圆@@@@,因此@@当晶圆@@变得越来越薄时@@@@,发生断裂的可能性也随之增加@@。而@@另一种晶圆@@切割@@方法@@——激光切割@@(Laser Dicing),在切割过程中则无需直接接触晶圆@@@@,而@@是在晶圆@@背面利用激光来完成切割@@,可非常有效地解决断裂问题@@。因为激光切割@@工艺@@能尽量避免对晶圆@@表面造成损害@@,可以保持芯片的坚固性@@,所以它更适用于切割较薄的晶圆@@@@。
随着晶圆@@厚度越来越小@@,先切割后研磨@@(DBG)这一方法从而@@被提出@@。DBG在晶圆@@切割@@过程中采取了相反@@的顺序@@,以减少芯片损坏@@。传统工艺@@先对晶圆@@背面进行研磨@@@@,再对晶圆@@进行切割@@@@;而@@DBG则先对晶圆@@进行部分切割@@,再对晶圆@@背面进行研磨@@@@,最后@@通过承载薄膜扩张法@@@@(MTE)4使其被彻底切割@@。
2 划片槽@@(Scribe Lane):从晶圆@@上切割芯片时@@@@,既不影响附近器件@@,又可满足切片分布所需的足够宽度的空间@@@@。
3 容差@@:性能差异导致的空间@@或@@数字上的误差范围@@。
4 承载薄膜扩张法@@(MTE):利用激光进行隐形切割并在晶圆@@上形成凹槽后@@,使贴在晶圆@@上的承载薄膜出现扩张@@。然后@@,在相应区域施加作用力@@,使晶圆@@分割@@成芯片@@。
第三步@@:芯片贴装@@
如图@@@@4所示@@,芯片贴装@@是指从承载薄膜上拾取经过晶圆@@切割@@后的芯片@@,并将其贴装在涂有粘合剂的基板或@@引线框架上的工艺@@@@@@。

图@@4:芯片贴装@@工艺@@@@(ⓒ HANOL出版社@@)
晶圆@@切割@@的过程中@@,需防止已切割的芯片从承载薄膜上脱落@@;而@@贴装的过程@@,则须将芯片从承载薄膜上顺利剥离@@。如果承载薄膜的黏附力太强@@,在剥离过程中可能会对芯片造成损坏@@。因此@@在晶圆@@切割@@过程中需确保粘合剂具有较强的粘合力@@;而@@在贴片之前@@,需用紫外线对晶圆@@进行照射@@,以减弱其粘合力@@,此时@@@@,只需从承载薄膜上剥离通过晶圆@@测试的芯片即可@@。
剥离出来的芯片必须使用粘合剂重新贴装到基板上@@,由于粘合剂的类型不同@@,所需的贴装工艺@@也有所不同@@。如果使用液体粘合剂@@,则必须使用类似于注射器的点液器或@@通过网@@板印刷@@@@(Stencil Printing)5提前将粘合剂涂在基板上@@。而@@固体粘合剂通常做成胶带的形式@@,也被称为晶片黏结薄膜@@(Die Attach Film, DAF)或@@晶圆@@背面迭片覆膜@@(WBL),则更适用于堆叠封装@@@@。在完成背面研磨@@后@@,在承载薄膜和晶圆@@背面之间粘贴晶片黏结薄膜@@;切割晶圆@@时@@@@,晶片黏结薄膜也会同时@@被切割@@;由于晶片黏结薄膜会连同其粘接的芯片一起脱落@@,因此@@可将晶片黏结薄膜粘接到基板上或@@其他芯片上@@。
5 网@@板印刷@@(Stencil Printing):一种使用镂空模板将糊状材料涂抹到诸如基板等器件的印刷方法@@。
第四步@@:互连@@
互连@@是指芯片之间@@、芯片与基板之间@@,以及封装@@体内其它组合间的电气连接@@。接下来@@将介绍引线键合@@及倒片键合@@(Flip Chip Bonding)这两种互连@@方式@@。
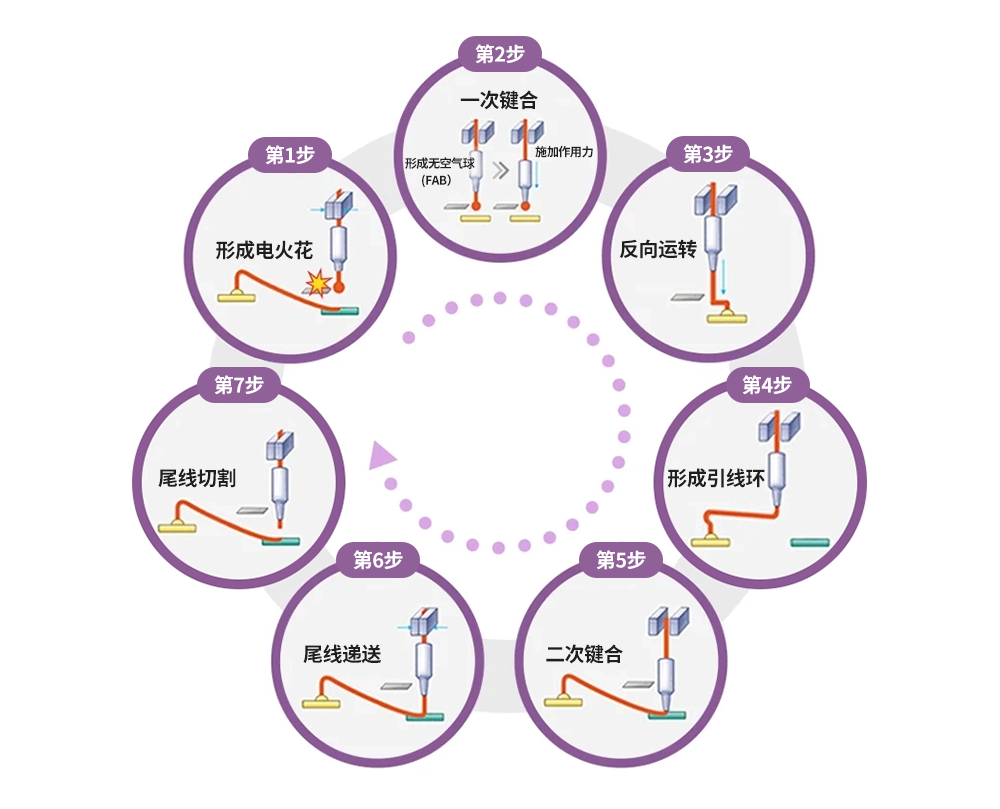
图@@1:5:引线键合@@工艺@@的七个步骤@@(ⓒ HANOL出版社@@)
引线键合@@
引线键合@@是使用金属线@@,利用热@@、压力和振动实现芯片与基板间的电气连接的工艺@@@@@@。金属引线的材质通常为金@@(Au),因为金具有良好的导电性和延展性@@。引线键合@@类似于缝纫@@,金属引线充当缝线@@,毛细管劈刀@@(Capillary)6充当缝针@@。引线宛如纱线缠绕在线轴并安装到设备@@上@@,之后将引线拉出@@,穿过毛细管劈刀@@正中央的小孔@@,在毛细管劈刀@@末端形成尾线@@@@。当采用电子@@火焰熄灭@@工艺@@@@(EFO)7在引线末端制造出强烈的电火花时@@@@,尾线部分将熔化并凝固@@,在表面张力作用下形成无空气球@@(FAB,Free Air Ball)。
FAB制作完成后需对其施压@@,使其粘合至焊盘@@,即完成一次球键合@@(Ball Bonding)。毛细管劈刀@@在基板移动时@@@@,引线会像缝线一样被拉出@@,形成一个引线环@@。向引线施加力量@@,将其按压到基板上的电气连接插脚@@,即金手指@@(Bond Finger),以此来实现针脚式键合@@@@(Stitch Bonding)8。针脚式键合@@后@@,向后拉紧引线@@,形成尾线@@,最后@@断开尾线@@,以完成芯片与基板间连接过程的最后@@一步@@。在引线键合@@过程中@@,其它芯片焊盘和基板金手指之间同样重复以上过程@@。
6 毛细管劈刀@@(Capillary):引线键合@@设备@@中辅助引线连接芯片电极与引线端子的工具@@。
7 电子@@火焰熄灭@@(EFO):用电火花熔化引线形成无空气球的工艺@@@@@@。
8 针脚式键合@@(Stitch Bonding):在半导体@@封装@@过程中@@,通过按压方式将引线键合@@到焊盘上@@。
倒片键合和底部填充@@
倒片键合是通过在芯片顶部形成的凸点来实现芯片与基板间的电气和机械连接@@。因此@@,倒片键合的电气性能优于引线键合@@@@。倒片键合分为两种类型@@:批量回流焊工艺@@@@(Mass Reflow,MR)和热压缩工艺@@@@(Thermo Compression)。批量回流焊工艺@@@@通过在高温下熔化接合处的锡球@@,将芯片与基板连接在一起@@。而@@热压缩工艺@@则通过向接合处施加热量和压力@@,实现芯片与基板间的连接@@。
仅仅依靠凸点无法处理芯片和基板之间因热膨胀系数@@@@(CTE)9差异所产生的应力@@,因此@@需要采用底部填充工艺@@@@,使用聚合物填充凸点间隙@@,以确保焊点可靠性@@。填充凸点间隙的底部填充工艺@@主要有两种@@:一是后填充@@(Post-Filling),即在倒片键合之后填充材料@@;二是预填充@@(Pre-Applied Underfill),即在倒片键合之前填充材料@@。此外@@,根据底部填充方法的不同@@,可将后填充分为毛细管底部填充@@(Capillary Underfill,CUF)和模塑@@底部填充@@(Molded Underfill,MUF)。毛细管底部填充是在倒片键合后@@,使用毛细管劈刀@@沿着芯片的侧面注入底部填充材料以填补凸点间隙@@;而@@模塑@@底部填充则是在倒片键合后@@,将环氧树脂模塑@@料作为底部充填材料来发挥填充作用@@。
9 热膨胀系数@@(CTE):一种材料性能@@,用于表示材料在受热情况下膨胀的程度@@。
第五步@@:模塑@@
芯片在完成引线键合@@或@@倒片键合后@@,需进行封装@@@@,以保护芯片结构免受外部冲击@@。此类保护工艺@@涵盖模塑@@@@、密封和焊接@@,但只有模塑@@工艺@@适用于塑料封装@@@@。模塑@@工艺@@使用环氧树脂模塑@@料@@,将热固性树脂@@@@(Thermosetting Resin)10与多种无机材料混合@@,封装@@在芯片@@、引线等部件周围进行保护@@,使这些部件免受外部物理性和化学性损害@@,并可根据实际需求制作成相应的封装@@尺寸或@@形状@@。
模塑@@工艺@@需在模具中进行@@。根据传递模塑@@法@@(Transfer Molding)的工艺@@@@,需要将引线键合@@连接芯片的基板放置在两个模具上@@,同时@@将环氧树脂模塑@@料片放置在中间@@,然后@@施加热量和压力@@,使固态环氧树脂模塑@@料熔化为液态@@,流入模具并填充间隙@@。但使用传递模塑@@法工艺@@也面临一些问题@@,随着芯片与封装@@顶部之间的空隙不断变小@@,使用环氧树脂模塑@@料等液体很难完成填充@@;此外@@,随着基板尺寸越来越大@@,模具尺寸也需相应加大@@,同样也加大了使用环氧树脂模塑@@料填充间隙的难度@@。
近年来@@,传递模塑@@法工艺@@已达到极致@@。随着封装@@内堆叠的芯片数量不断增加@@,封装@@厚度逐渐变薄@@,芯片与封装@@顶部之间的空隙持续缩小@@。为了降低制造成本@@,芯片被大批量加工@@,基板的尺寸也在不断增大@@。因此@@,压缩模塑@@法@@(Compression Molding)成为了填充小空隙的解决方案@@。在压缩模塑@@法@@的工艺@@@@中@@,模具中会预先填充环氧树脂模塑@@料粉末@@,基板放入模具中后@@,随后施加热量和压力@@,模具中填充的环氧树脂模塑@@料粉末会液化并最终成型@@。在这种情况下@@,环氧树脂模塑@@料会即刻熔化为液体@@,无需流动便可填充间隙@@,因此@@成为了填充芯片与封装@@顶部之间小空隙的理想选择@@。
10 热固性树脂@@(Thermosetting Resin):一种稳定的聚合物材料@@,在加热后会发生聚合反应从而@@硬化并形成聚合物@@。它主要用于制作环氧树脂模塑@@料@@,通过防止热损伤@@、机械损伤@@,及腐蚀以保护半导体@@电路的电子@@和电气性能@@。
第六步@@:打标@@
打标@@(Marking)是指在半导体@@封装@@表面刻印产品信息的工艺@@@@@@,包括半导体@@类型@@、制造商@@,以及客户要求的图@@案@@、符号@@、数字或@@字母等@@。这在封装@@后的半导体@@产品出现故障时@@尤为重要@@,因为标记有助于追踪产品故障原因等@@。打标@@既可以使用激光灼烧环氧树脂模塑@@料等材料来进行刻印@@,也可以使用油墨压印@@。
对于塑料封装@@@@,必须在封装@@表面刻印所需信息之前进行模塑@@@@。由于激光打标@@只是简单的刻印行为@@,所以黑色环氧树脂模塑@@料通常会作为首选@@,因为它可以增加标记的易读性@@。考虑到刻印字符或@@符号@@不易着色@@,因此@@,在黑色背景上刻印会使标记更加明显@@。接下来@@两个步骤是基板封装@@的最后@@阶段@@,也是基板封装@@和引线框架封装@@工艺@@之间的区别所在@@。
第七步@@:植球@@
基板封装@@中的锡球不仅可以作为封装@@体和外部电路之间的电气通路@@,还可提供机械连接@@。植球@@工艺@@是将锡球粘合至基板焊盘的过程@@。在该工艺@@的第一步@@@@,将助焊剂@@@@(Flux)11涂抹在焊盘上@@,并将锡球放置在焊盘上@@。然后@@通过回流焊工艺@@@@熔化并粘合锡球@@,之后清洗并去除助焊剂@@@@。助焊剂@@的作用是在回流焊过程中清除锡球表面杂质和氧化物@@,使锡球均匀熔化@@,形成洁净表面@@。锡球熔化后便会流入基板上覆盖的网@@板@@,即可填充网@@板上的每个孔隙@@。最后@@,将基板和网@@板分离@@,但因助焊剂@@具有黏附力@@,锡球仍然会留在基板上@@。由于焊盘上预先涂抹了助焊剂@@@@,因此@@锡球会暂时@@粘合并附着在焊盘上@@。

图@@6:回流焊工艺@@的温度曲线@@(ⓒ HANOL出版社@@)
通过回流焊工艺@@@@,在助焊剂@@的作用下附着于基板焊盘上锡球会熔化@@。图@@6显示了回流焊工艺@@的温度曲线@@@@。在锡球达到熔化温度之前@@,助焊剂@@会在吸热区@@(Soak Zone)被激活@@,以清除锡球表面氧化物和杂质@@。当温度高于熔化温度时@@@@,锡球会熔化并粘合在焊盘上@@,但熔化后的锡球不会完全流走@@。相反@@,它们会在表面张力的作用下@@,在除了其与焊盘粘合在一起的金属部分以外的所有区域@@,形成一个球形@@。随着温度逐渐下降@@,锡球会保持其形状并再次凝固@@。
11 助焊剂@@(Flux):一种有助锡球附着在铜表面的水溶性和油溶性溶剂@@。
第八步@@:切单@@
切单@@(Singulation)是基板封装@@工艺@@的最后@@一道工序@@。即使用刀片将成品基板切割为单独的封装@@@@。切单@@完成后@@,将封装@@放在托盘上进行测试@@,并完成其余步骤@@。
传统封装@@工艺@@组装涉及的各个步骤彰显了精准对齐@@、最佳电气连接@@、坚固保护措施以防止外部损坏等要素@@,这些步骤在封装@@流程中都是不可或@@缺的@@。在下一篇文章中@@,我们将详细探讨半导体@@封装@@的另一种主要类型@@---晶圆@@级封装@@@@。
本文转载自@@:SK海力士@@
