作者@@:半导体工艺与整合@@ (SPI) 资深工程师@@ Assawer Soussou 博士@@
1. 介绍@@
随着技术@@推进到@@1.5nm及更先进节点@@,后段器件集成将会遇到新的难题@@,比如需要降低金属间距@@和@@支持新的工艺流程@@。为了强化电阻电容性能@@、减小边缘定位误差@@,并实现具有挑战性的制造工艺@@,需要进行工艺调整@@。为应对这些挑战@@,我们尝试在@@1.5nm节点后段自对准图@@形化中使用@@半大马士革方法@@。我们在@@imec生产了一组新的后段器件集成掩膜版@@,以对单大马士革和@@双大马士革进行电性评估@@。新掩膜版的@@金属间距@@分别为@@14nm、16nm、18nm、20nm和@@22nm,前两类是@@1.5nm节点后段的最小目标金属间距@@@@,后三类用于工艺窗口评估@@。
SEMulator3D®虚拟制造平台可以展示下一代半大马士革工艺流程@@@@,并使用@@新掩膜版研究@@后段器件集成的工艺假设和@@挑战@@。此外@@,我们还使用@@@@新掩膜版模拟和@@测试了用于提升电阻电容性能和@@改进制造的额外工艺@@。
2. 在自对准图@@形化中使用@@半大马士革方法@@
使用@@间隙填充和@@间隔层去除方案@@,我们提出在自对准图@@形化中使用@@半大马士革方法@@@@。
间隔层去除方案需要选择性刻蚀@@工艺@@。区域选择性沉积@@ (ASD) 是填充@@LE2间隙的最佳沉积选择@@。图@@1 (a) 展示间隙填充工艺的剖面图@@@@,以及间隔层和@@@@LE1核心的位置@@。通过使用@@@@SEMulator3D软件@@,我们可以更好地研究@@间隙填充方案和@@间隔层去除方案会面临的挑战@@。

图@@1:1.5nm节点图@@形化工艺的间隙填充和@@间隔层去除方案@@
3. 半大马士革工艺流程@@
我们还使用@@@@SEMulator3D虚拟制造对半大马士革工艺流程@@进行了模拟@@。图@@2展示模拟出的工艺流程@@。使用@@SALELE(自对准光刻@@@@-刻蚀@@-光刻@@-刻蚀@@)方法对金属@@2进行了图@@形化@@,并使用@@极紫外光刻@@将其连接到金属@@3。之后@@,使用@@模拟的工艺流程对金属@@2图@@形化和@@金属@@2与金属@@3的连接进行敏感性分析@@。

图@@2:使用@@新掩膜版进行后段器件集成的半大马士革工艺流程@@@@
4. 工艺助推器@@
图@@3展示新掩膜版的@@工艺助推器@@@@。我们也使用@@@@SEMulator3D来模拟和@@分析这些掩膜版助推器的可行性和@@性能@@。

图@@3:掩膜版的@@1.5nm节点工艺助推器@@@@
5. 混合高度@@
通过定制金属线的高度@@,可以完全优化电阻电容性能@@(如图@@@@4),而金属线高度的灵活性可以通过刻蚀@@金属线实现@@。高金属线电阻低@@、电容高@@,因此可能适用于电源线和@@长信号线@@;短金属线电阻高@@、电容低@@,因此最有可能适用于信号线@@。我们使用@@@@SEMulator3D对这一概念进行了初步分析@@。
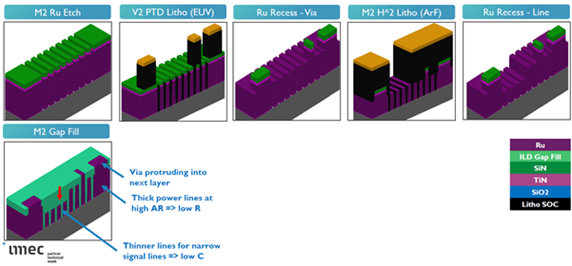
图@@4:为优化电阻电容产品性能进行的混合高度@@定制@@
6. 类似自对准的通孔对准@@(SAB)
自对准图@@形化技术@@最早被用于@@14nm节点的互连技术@@@@。为了生成有效器件@@,需要切断由这一技术@@产生的平行金属线@@。这种切断掩膜的边缘定位误差很有挑战性@@,因此在@@10nm和@@7nm节点开发了自对准区块技术@@@@,将套刻允许误差扩大到@@¾间距@@。边缘定位误差在@@1.5nm技术@@节点会更具挑战性@@,我们预计这一自对准技术@@需要扩展至通孔层@@。此时@@,我们再次使用@@@@SEMulator3D研究@@1.5nm节点通孔自对准的不同选择@@(如图@@@@5)。

图@@5:使用@@半大马士革自对准通孔以改善通孔套刻精度@@
7. 空气间隙@@
为进行大马士革工艺引入了空气间隙@@@@,但还需要额外的刻蚀@@步骤来去除薄层间介质@@。在直接金属刻蚀@@中@@@@,工艺结束时会沉积薄层间介质@@。沉积工艺可以在间距@@紧密处夹止二氧化硅@@,从而形成空气间隙@@@@。在模拟中@@,我们探索了空气间隙@@形成的基本模型@@,并计划了额外的模拟项目@@。在初始工艺流程中@@,我们模拟了简单的空气间隙@@填充@@、氧化物间隙填充和@@化学机械抛光@@ (CMP)。我们使用@@@@SEMulator3D模拟了这一工艺流程@@(如图@@@@6)。

图@@6:空气间隙@@工艺形成模拟@@
8. 高深宽比金属线@@
在传统的大马士革工艺中@@,深宽比通常限于@@2左右@@。超过这个深宽比@@,就很难在不形成空隙的情况下沉积金属线了@@。直接金属刻蚀@@中@@,金属高度受限于刻蚀@@工艺@@,深宽比可以达到甚至超过@@5。因为电阻随着尺寸的减小而增加@@,这对于先进节点来说是很重要的工艺助推器@@@@。增加金属高度是持续电阻微缩的重要方法@@。直接金属刻蚀@@工艺的关键挑战是减少刻蚀@@过程中的硬掩膜消耗@@。我们使用@@@@SEMulator3D对这一挑战进行了建模@@。
9. 混合金属化@@
为了减少总电阻@@,可以为金属线和@@通孔使用@@不同的金属@@。imec正在研究@@中对这一方面进行探索@@。
10. 结论@@
我们使用@@@@SEMulator3D定义和@@模拟@@1.5nm及更先进节点@@的后段工艺流程@@。基于这些模拟结果@@,我们建立了新掩膜版的@@设计规则@@。使用@@模拟推荐的工艺流程@@,我们成功试产了掩膜版@@。SEMulator3D模拟出性能助推器的原始概念后@@,我们也在硅片上对完全自对准通孔@@、高深宽比金属线@@和@@空气间隙@@等工艺助推器@@进行了演示@@。这些模拟结果有助于@@imec先进节点领域的研究@@@@,并作用于硅芯片这个终端产品上@@。
鸣谢@@
感谢@@Martin O'Toole和@@imec向泛林集团@@分享这项研究@@@@。该研究@@得到了@@IT2 ECSEL Joint Undertaking的支持@@。
