半大马士革集成中引入空气间隙结构面临的挑战@@
judy -- 周一@@, 12/18/2023 - 15:06
随着器件微缩至@@3nm及以下节点@@,后段模块处理迎来许多新的挑战@@,这使芯片制造商开始考虑新的后段集成方案@@

随着器件微缩至@@3nm及以下节点@@,后段模块处理迎来许多新的挑战@@,这使芯片制造商开始考虑新的后段集成方案@@

本文将举例说明如何借助虚拟制造评估@@ DRAM 电容器图形化工艺的工艺窗口@@

随着技术@@推进到@@1.5nm及更先进节点@@,后段器件集成将会遇到新的难题@@,比如需要降低金属间距和支持新的工艺流程@@

动态随机存取存储器@@ (DRAM) 是一种集成电路@@,目前广泛应用于需要低成本和高容量内存的数字电子@@设备@@@@

泛林集团@@推出了@@Coronus DX产品@@,这是业界首个晶圆边缘沉积解决方案@@,旨在更好地应对下一代逻辑@@、3D NAND和先进封装应用中的关键制造挑战@@
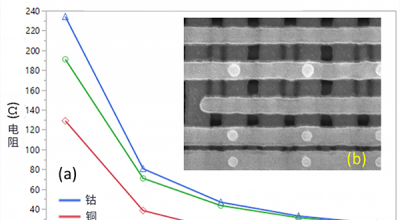
由后段制程@@(BEOL)金属线寄生电阻电容@@(RC)造成的延迟已成为限制先进节点芯片性能的主要因素@@

随着电子@@设备@@精密化@@,人们愈发要求半导体技术@@能以更低的成本实现更优的性能和更大的容量@@。这些趋势推动了半导体技术@@的重大进步@@,在过去十年中@@2D NAND逐渐过渡到@@3D NAND。

元宇宙是@@Meta®的愿景@@,即与真实的物理世界连接的虚拟世界互连网@@络@@。虽然大家都在热议元宇宙@@,但多数人对元宇宙的功能和实现方式仍处于雾里看花的阶段@@

本文将说明我们在高深宽比通孔钨填充工艺中@@,利用虚拟@@DOE实现了对空隙的有效控制和消除@@。
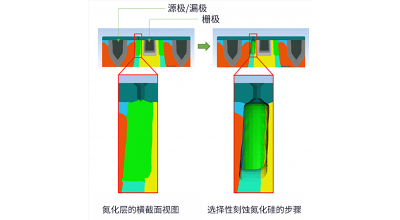
本文中@@,我们将专注于前道工序@@ (FEOL),并演示在栅极和源极@@/漏极之间引入空气间隙的@@SEMulator3D®模型@@